从引线键合到倒装的转变,代表了从传统封装向先进封装的迭代。在采用倒装形式的半导体 产品中,大部分芯片采用凸点作为互连材料,凸点互连的极限方向是无凸点互连,也即混合键合。混合键合由于没有凸点和焊料,可以实现极细微的间距,从而极大地增强连接密度。根据 SK 海力士展示的技术路线图,在未来的 HBM4 这一代产品中,为了实现更多层数的堆叠(达到 12Hi/16Hi),SK 海力士或将引入混合键合,降低存储芯片堆叠中间的空隙高度。
键合方式是决定芯片封装性能的关键工艺
键合方式决定了一个芯片产品对内对外的连接。从引线键合到倒装的转变,代表了从传统封装向先进封装(四川半导体封装设备有哪些?)的迭代。在采用倒装形式的半导体(半导体封装检测设备有哪些?)产品中,大部分芯片 采用凸点作为互连材料,凸点按照材料分类主要包括以铜柱凸点、金凸点、镍凸 点、铟凸点等为代表的单质金属凸点,和以锡基焊料为代表的焊料凸点及聚合物 凸点等。凸点互连的极限方向是无凸点互连,也即混合键合。
混合键合可以实现极细微的间距,成长空间广阔
混合键合由于没有凸点和焊料,可以实现极细微的间距,从而极大地增强连接密 度,根据 semianalysis 的统计,混合键合可以实现 0.5-0.1μm 的间距,连接密 度可以做到 10K-1MM/mm²,显著高于之前的各代键合技术。根据 Yole 的统计,D2W (Die to Wafer)混合键合设备市场规模或将从 2020 年的 600 万美元增加至 2027 年的 2.32 亿美元,期间 CAGR 高达 69%,显著高于键合设备整体市场增速。
HBM4 或将引入混合键合封装技术
根据 SK 海力士展示的技术路线图,在未来的 HBM4 这一代产品中,为了实现更多 层数的堆叠(达到 12Hi/16Hi),SK 海力士或将引入混合键合,降低存储芯片堆叠 缝隙的高度。而另一大存储巨头三星电子先进封装团队高管 Dae Woo Kim 表示三 星电子成功制造了基于混合键合技术的 16 层堆叠 HBM3 内存,该内存样品工作正 常,未来 16 层堆叠混合键合技术将用于 HBM4 内存量产。
1. 混合键合或将成为堆叠封装的关键技术
1.1 高端先进封装有望逐步引入混合键合技术
键合方式是决定芯片性能的关键工艺。键合方式决定了一个芯片产品对内对外的连 接。从引线键合到倒装的转变,代表了从传统封装向先进封装的迭代。在采用倒装形 式的半导体产品中,大部分芯片采用凸点作为互连材料,凸点按照材料分类主要包括 以铜柱凸点(Cu Pillar)、金凸点(Au Bump)、镍凸点(Ni Bump)、铟凸点(In Bump) 等为代表的单质金属凸点,和以锡基焊料为代表的焊料凸点(Solder Bump)及聚合物凸点等。凸点互连的极限方向是无凸点互连(Bumpless Interconnection),也即混合键合 (Hybrid bonding)。混合键合指的是将两个或多个芯片的金属层(材质通常为铜) 精密对准并直接压合,形成直接的电学接触。上下两个芯片均没有凸点,也不需要使 用焊料,而只有铜焊盘作为对外互连的接口。
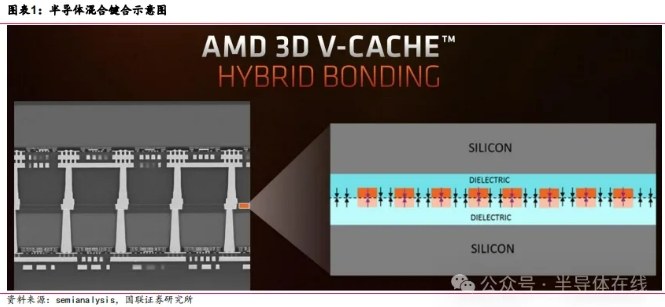
混合键合可以实现极细微的间距。和引线键合以及凸点互连等键合方式相比,混合键 合由于没有凸点和焊料,可以实现极细微的间距,从而极大地增强连接密度,根据 semianalysis 的统计,混合键合可以实现 0.5-0.1μm 的间距,连接密度可以做到 10K-1MM/mm²,显著高于之前的各代键合技术。
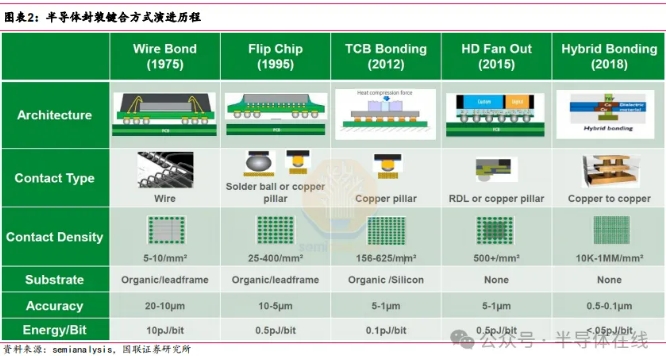
主流的键合方式包括直接键合互联、等离子体活化键合、热压键合等多种方式,其中 混合键合材料主要包括金/氧化硅、铝/氧化硅、铜/氧化硅及其他材料的相互组合。美国 Ziptronix(现 Xperi)公司开发的直接键合互连(Direct Bond Interconnect, DBI)技术是目前较为成熟的混合键合技术。对于采用聚合物胶作为介质材料的混合键合,热压键合是主要方法。

主流的混合键合方案包括铜/氧化硅、铜/聚合物胶,以及由微凸点键合技术和非流动性底部填充(No-Flow Underfill)技术改进而来的微凸点/聚合物胶混合键合。以铜 /氧化硅混合键合技术为例,工艺流程主要包括化学机械抛光、表面活化、对准和氧 化硅-氧化硅键合(室温下)、铜铜键合(加热退火)。

混合键合设备有望进入增长快车道。根据 Yole 的统计,D2W(Die to Wafer)混合键 合设备市场规模或将从 2020 年的 600 万美元增加至 2027 年的 2.32 亿美元,期间 CAGR 高达 69%,显著高于键合设备整体市场增速;而包含部分混合键合设备在内的 W2W(Wafer to Wafer)永久键合设备市场规模有望从 2020 年的 2.61 亿美元增至 2027 年的 5.07 亿美元,期间 CAGR 约为 16%,同样高于市场整体增速。
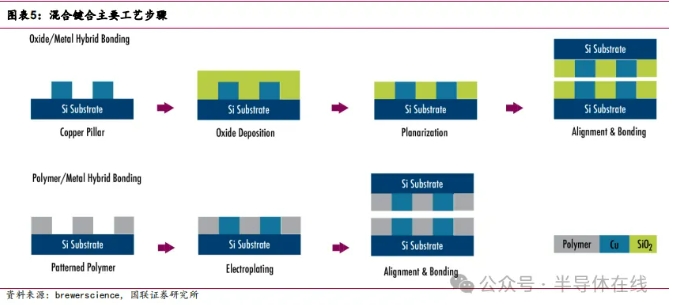
1.2 HBM4 或将引入混合键合技术提升堆叠层数
HBM3/HBM3E 仍然使用凸点互连的键合方式。HBM 全称 High Bandwidth Memory,意为 高带宽内存,通过 3D 堆叠封装的方式集成多片 DRAM 芯片。相比于 DDR4、GDDR5 可 以实现更少的功耗、更小的面积、更高的带宽和容量,常用于搭配 CPU、GPU 或其他 类型的高性能计算类芯片。以海力士 HBM 产品为例,目前量产的主流世代产品 HBM3/HBM3E 仍然采用 MR-MUF 封装技术,即塑封底填+回流焊(四川省微电瑞芯科技有限公司半导体设备-平行封焊机)的形式,通过凸点键合 的方式连接堆叠的各层存储芯片。
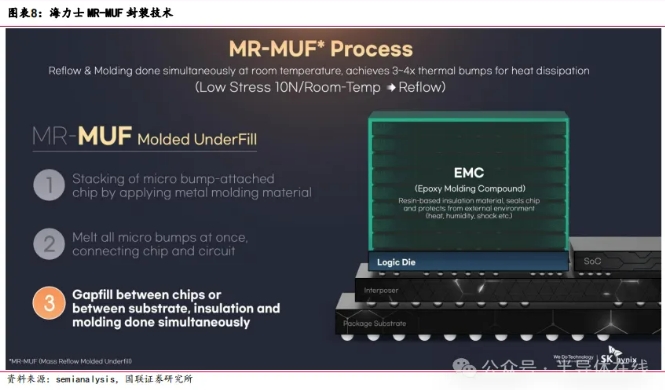
下一代产品 HBM4 或将引入混合键合技术。根据 SK 海力士展示的技术路线图,在未来的 HBM4 这一代产品中,为了实现更多层数的堆叠(达到 12Hi/16Hi),SK 海力士或 将引入混合键合,降低存储芯片堆叠缝隙的高度。而另一大存储巨头三星电子先进封装团队高管 Dae Woo Kim 表示三星电子成功制造了基于混合键合技术的 16 层堆叠 HBM3 内存,该内存样品工作正常,未来 16 层堆叠混合键合技术将用于 HBM4 内存量产。
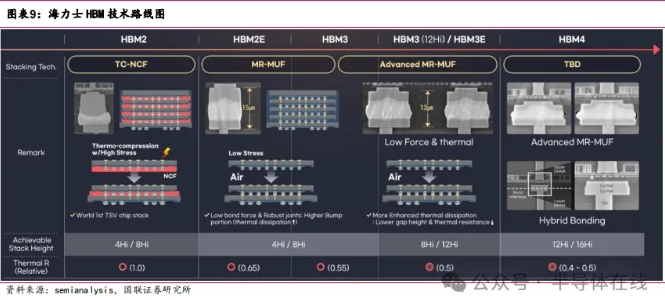
2. 投资建议
2.1 建议关注算力产业链
全球 AI 大模型不断迭代升级,AI 应用快速发展,国内以 Kimi 为代表的国产大模型 用户体验非常流畅,建议关注算力产业链。同时,算力需求带动 HBM 需求同步增长, 建议关注 HBM 产业链。相关标的:雅克科技、华海诚科等。
2.2 建议关注消费电子复苏及 AI 终端落地
自 2023 年 Q3 以来,消费电子逐步进入复苏周期,同时多家消费电子终端品牌厂商 陆续推出新的 AI 硬件产品,包括 AI PC、AI 手机、AI Pin 等多种类型。因此我们认 为 AI PC、AI 手机等终端产品的推出,叠加换机周期的到来,有望促进消费电子终端 销量重回增长轨道,建议关注 AI 硬件产业链。相关标的:维信诺等。
2.3建议关注半导体复苏周期
下游库存经历较为充分的去化,同时 AI 相关领域带来新的需求增量,半导体经济周 期有望于 2024 年迎来反弹,建议关注国产 IC 制造产业链。相关标的:中芯国际、长 电科技、芯源微等。自 2023 年 Q3 以来,消费电子逐步进入复苏周期,同时多家消费 电子终端品牌厂商陆续推出新的 AI 硬件产品,包括 AI PC、AI 手机、AI Pin 等多种 类型。因此我们认为 AI PC、AI 手机等终端产品的推出,叠加换机周期的到来,有望促进消费电子终端销量重回增长轨道,建议关注 AI 硬件产业链。相关标的:维信诺等。
3. 风险提示
混合键合技术研发不及预期的风险。混合键合技术可以有效降低芯片堆叠间隙的高度,但因为是直接键合,所以对于芯片表面的平整度和清洁度均有着极高的要求,这 就意味着需要进行非常精细化的研磨抛光和清洗(自动清洗机),技术难度较高,如果相关技术环节研发进度不及预期,或将对混合键合技术的产业化带来不利影响。
混合键合技术成本难以降低的风险。混合键合技术需要非常精细化的研磨抛光和清洗(半导体清洗设备),对键合设备的要求也极高,同时在产业化前期或将面临良率较低的情况。因此混 合键合技术产业化前期的成本或将较为高昂,如果迟迟无法降低成本,或将给混合键合技术的应用和推广带来不利影响。
免责声明:文章归原作者所有,转载仅为分享和学习使用,不做任何商业用途!内容如有侵权,请联系本部删除!小编:19181980439
更多的四川半导体微组装设备资讯请联系:18980821008(张生)19382102018(冯小姐)
四川省微电瑞芯科技有限公司http://www.wdrx-semi.com/





