半导体制造工艺流程
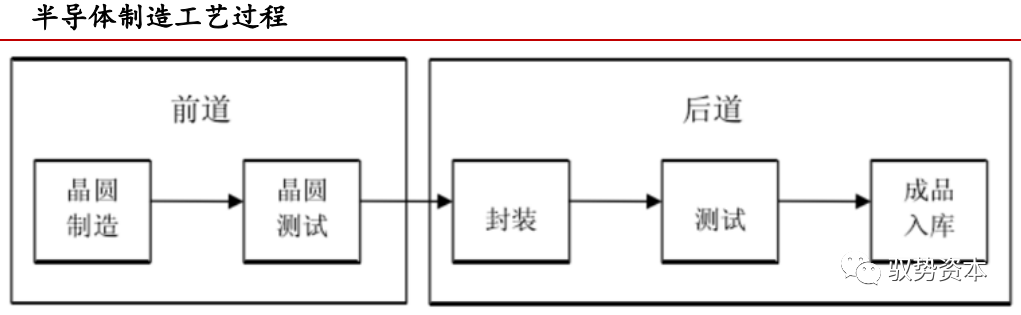 半导体器件制作工艺分为前道和后道工序,晶圆制造和测试被称为前道(Front End)工序,而芯片的封装、测试及成品入库则被称为后道(Back End)工序,前道和后道一般在不同的工厂分开处理。
半导体器件制作工艺分为前道和后道工序,晶圆制造和测试被称为前道(Front End)工序,而芯片的封装、测试及成品入库则被称为后道(Back End)工序,前道和后道一般在不同的工厂分开处理。 加微信进群
加微信进群
半导体制造工艺和流程
半导体制造工艺和流程

封装的基本定义和内涵
封装的功能
微电子封装的功能
封装的范围
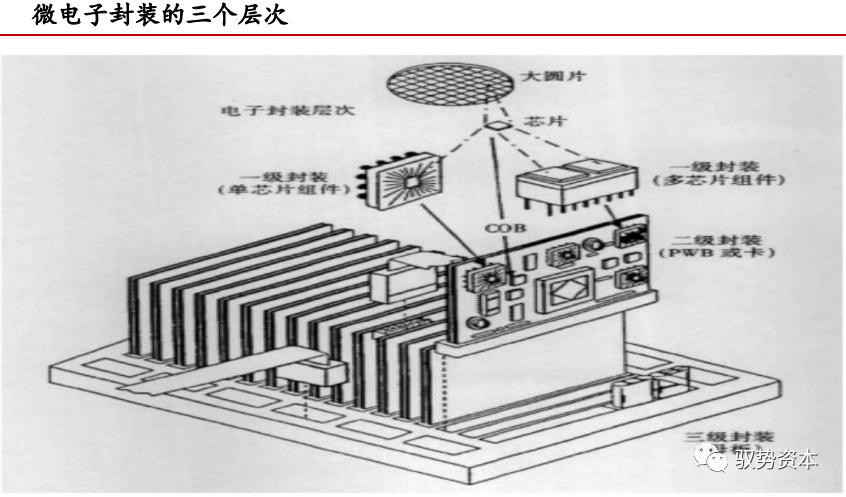
微电子封装的三个层次
电子封装的工程的六个阶段
封装基板和三级封装
传统集成电路(IC)封装的主要生产过程
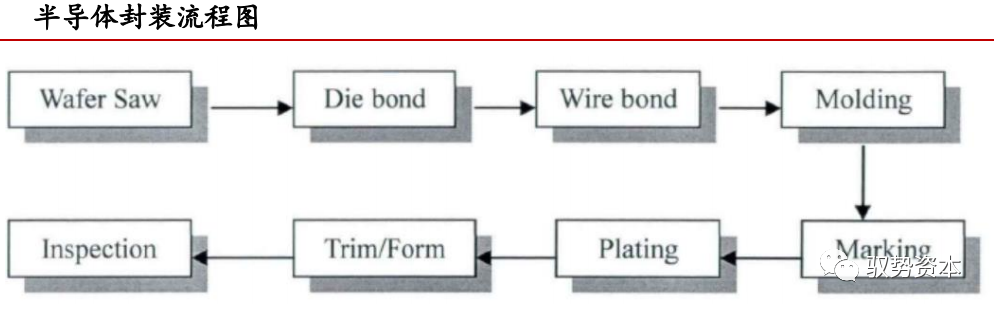
传统半导体封装的七道工序
半导体封装技术
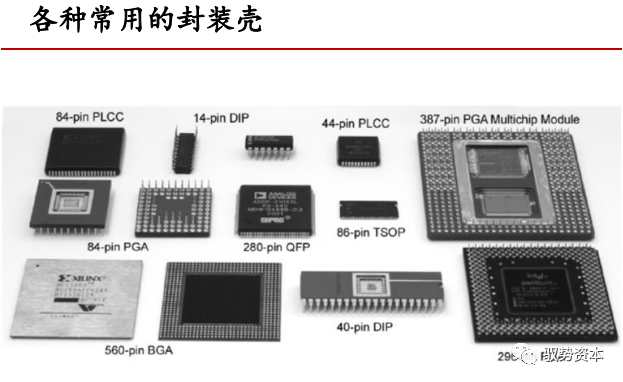
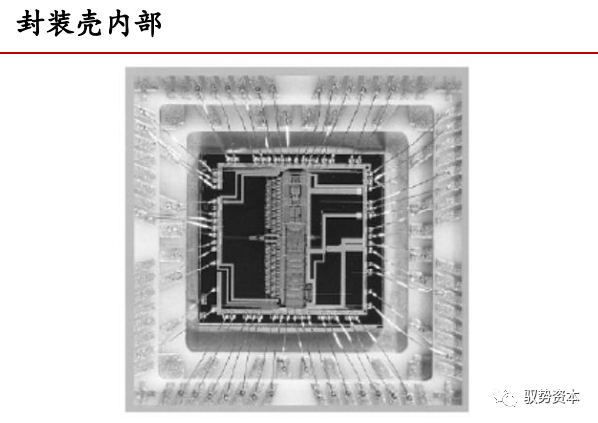
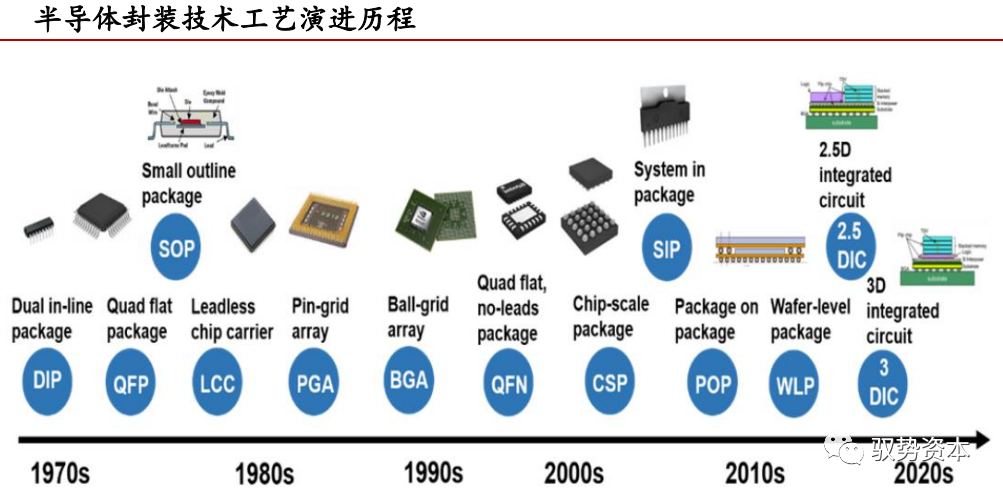
半导体封装技术的发展历史
半导体封装材料
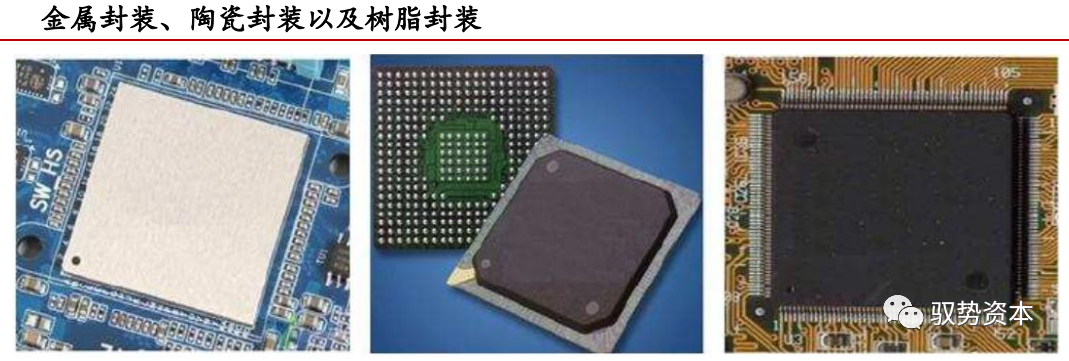
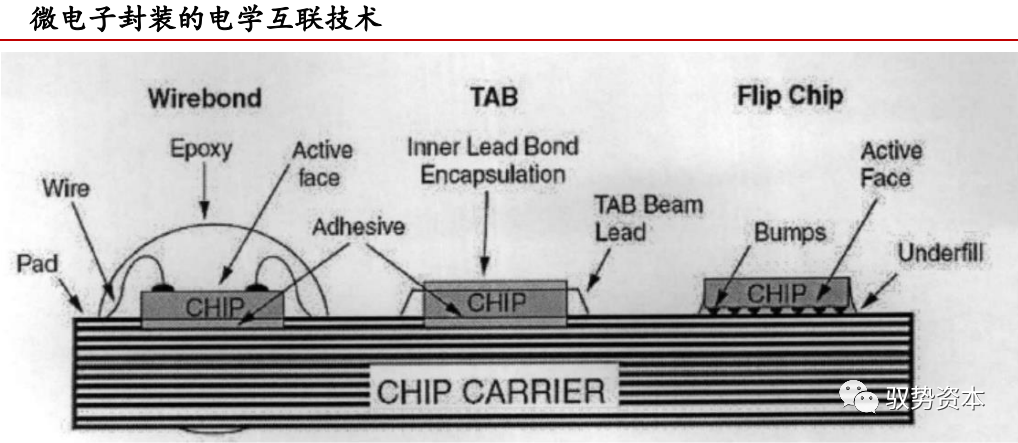
芯片电学互连(零级封装)的三种方式
半导体封装的典型封装工艺简介

小型塑封晶体管(Small Outline Transistor,SOT) 小引出线封装(Smal lOutline Package,SOP) 四方扁平无引线封装(Quad Flat No-lead Package,QFN) 薄小缩小外形封装(Thin Small Shrink Outline Package,TSSOP) 方型扁平式封装(Quad Flat Package,QFP) 方形扁平无引脚封装(QFN)
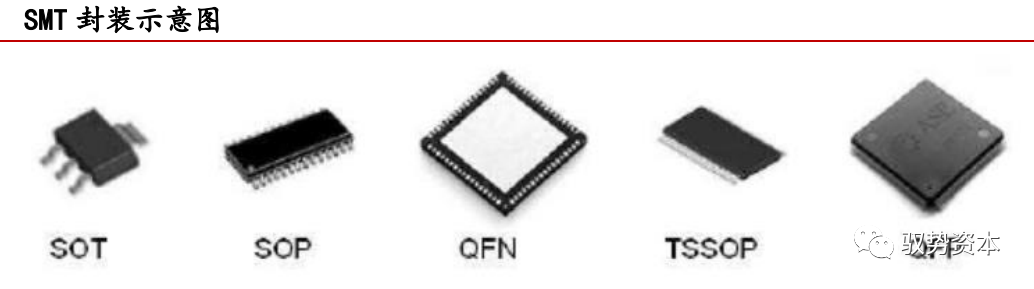

芯片封装的失效率较低; 提升器件管脚数量与封装壳尺寸的比率,减小了基板面积; 管脚共面较好,减少管脚共面损害带来的焊接不良; BGA引脚为焊料值球,不存在引脚变形问题; BGA封装引脚较短,输入/输出信号链路大大缩短,减少了因管脚长度引入的电阻/电容/电感效应,改善了封装壳的寄生参数; BGA球栅阵列与PCB板接触点较多,接触面积较大,有利于芯片散热,BGA封装有利提高封装的封装密度。
芯片级(CSP)封装技术
CSP的芯片面积与封装面积之比与1:1的理想状况非常接近,绝对尺寸为32mm2,相当于BGA的三分之一和TSOP的六分之一,即CSP可将内存容量提高3~6倍之多。 测试结果显示,CSP可使芯片88.4%的工作热量传导至PCB,热阻为35℃/W-1,而TSOP仅能传导总热量的71.3%,热阻为40℃/W-1。 CSP所采用的中心球形引脚形式能有效地缩短信号的传导距离,信号衰减也随之减少,芯片的抗干扰、抗噪性能更强,存取时间比BGA减少15%~20%,完全能适应DDRⅡ,DRDRAM等超高频率内存芯片的实际需要。 CSP可容易地制造出超过1000根信号引脚数,即使最复杂的内存芯片都能封装,在引脚数相同的情况下,CSP的组装远比BGA容易。CSP还可进行全面老化、筛选、测试,且操作、修整方便,能获得真正的KGD(Known GoodDie已知合格芯片)芯片。
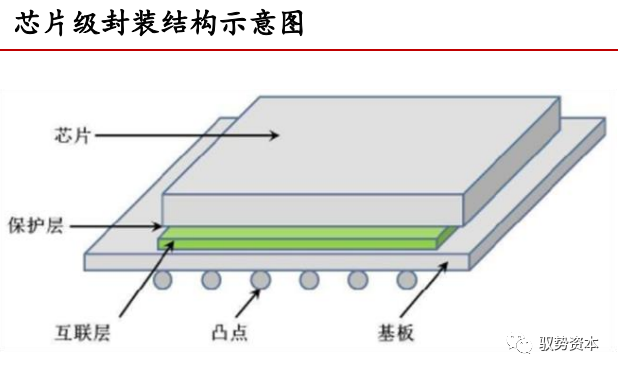
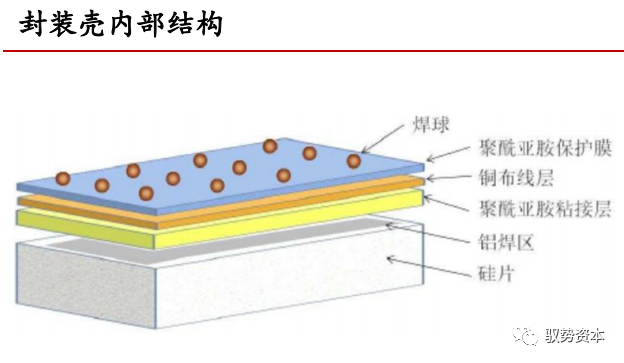
CSP封装形式主要有如下分类
先进封装
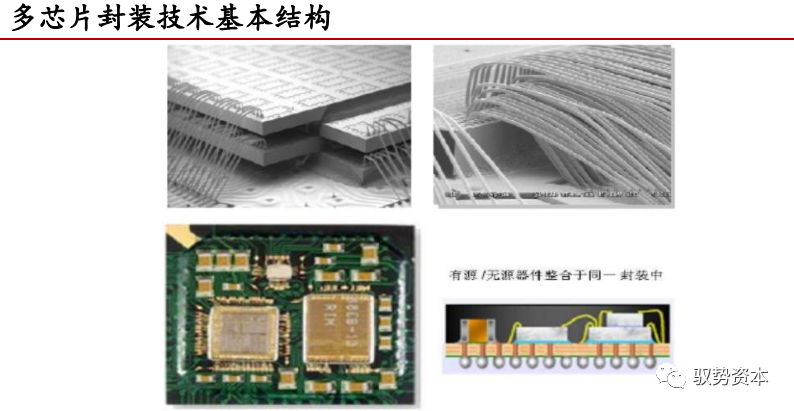
晶圆级封装(WLP)
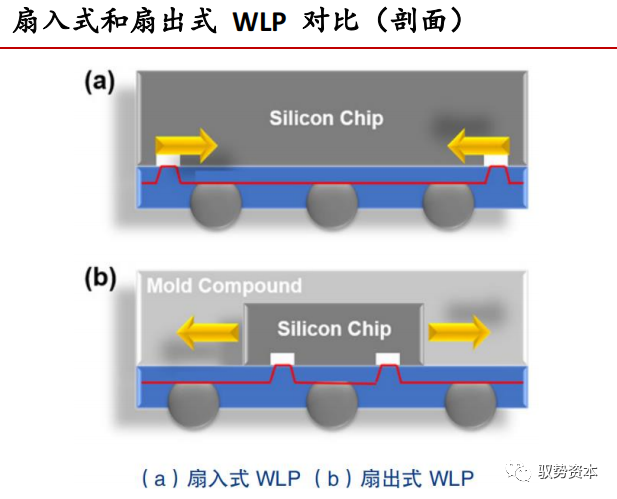
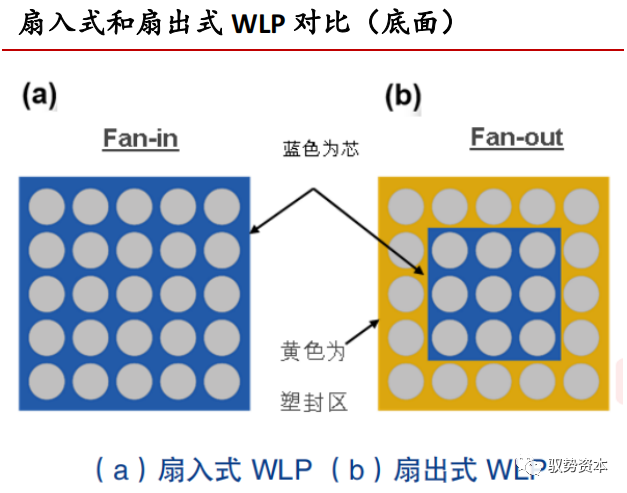
2.5D/3D先进封装集成工艺
系统级封装SiP技术
SIP/SOP
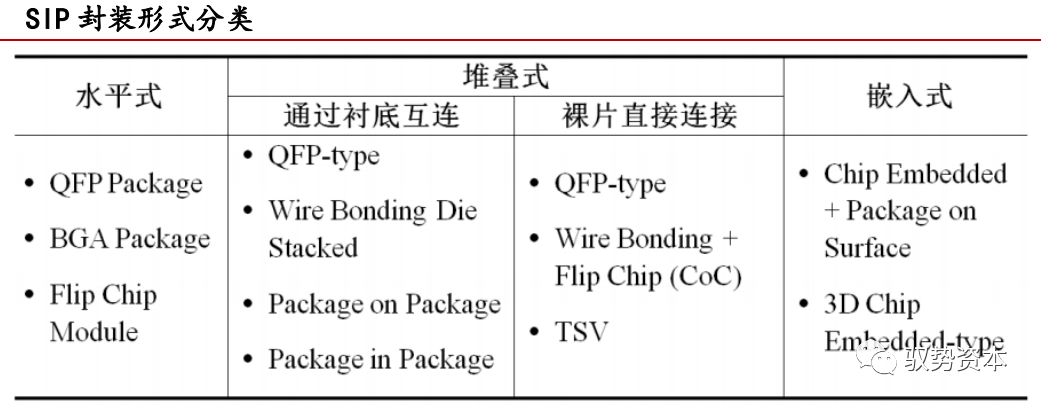
多芯片组件(MCM)
芯片封装技术分类
多芯片组件(MCM)
芯片封装技术分类
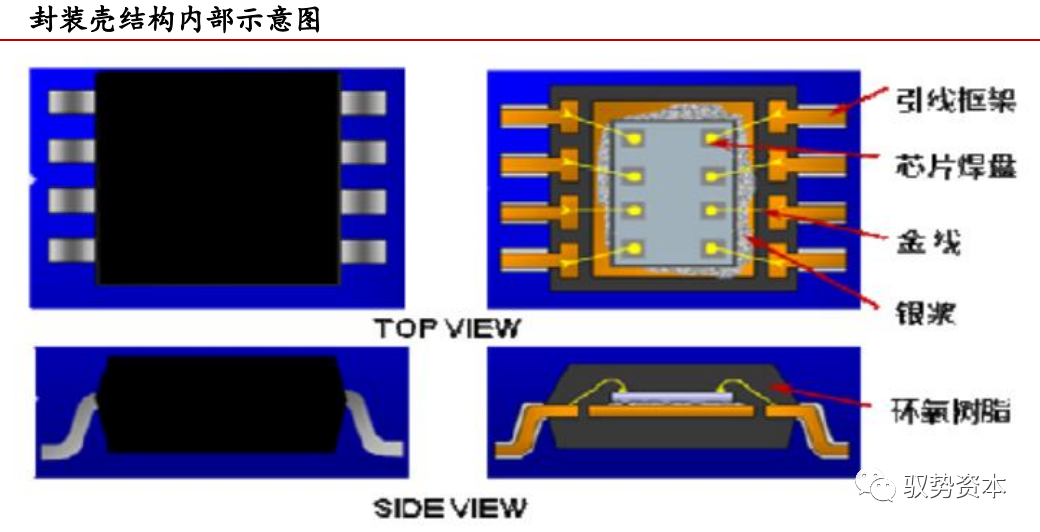
引线框架封装中引线的功能
镶入式封装技术-基于基板的封装
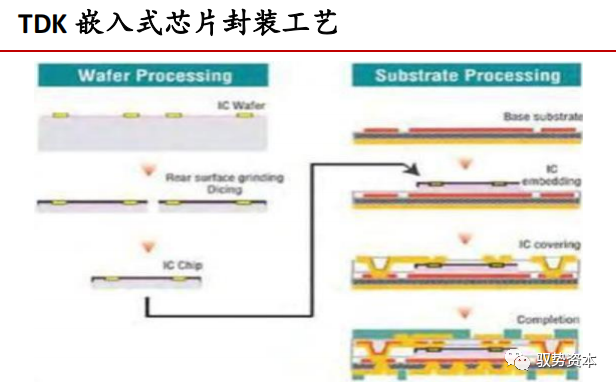
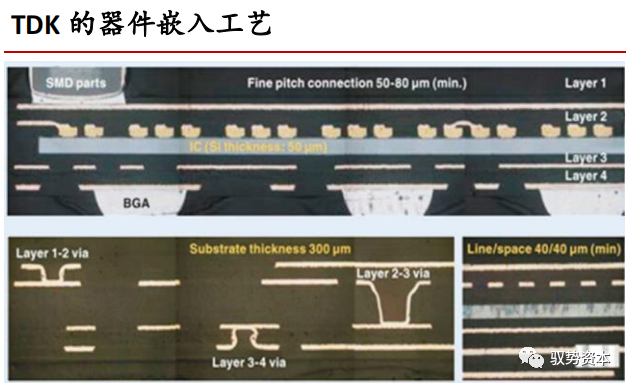
镶入式封装的优劣势
按基板类型的镶入式封装分类
裸芯片封装/晶圆级封装(WLP)
裸芯片封装/组装
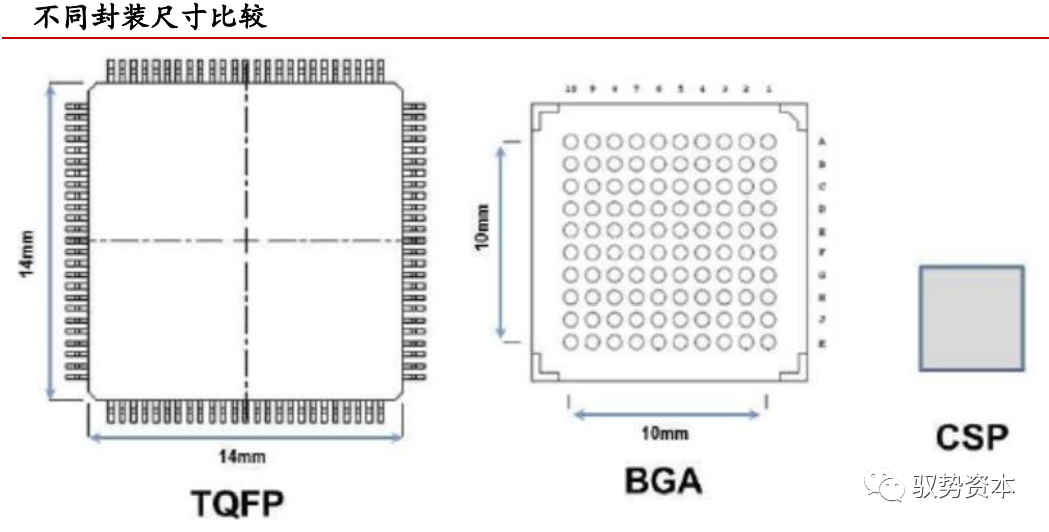
晶圆级封装(WLP)
封装基板的定义
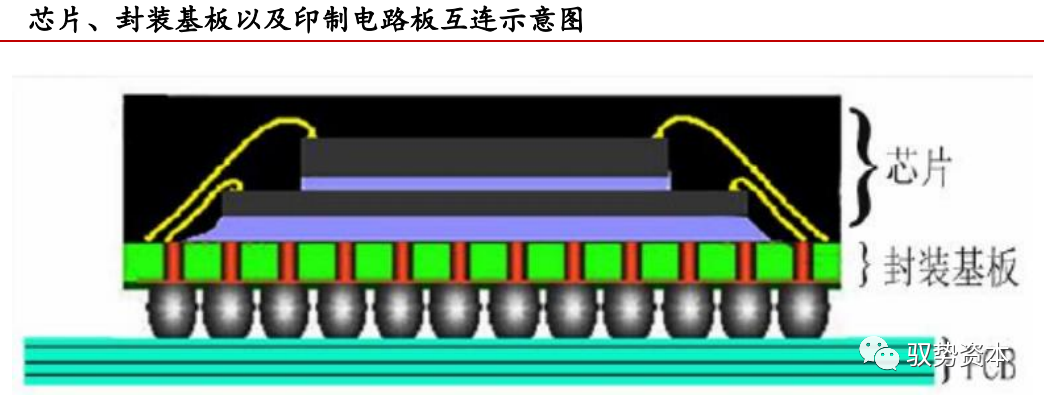
封装基板的作用
集成电路封装基板在电子封装工程中的作用
封装基板发展的三个阶段
封装基板的发展历史
封装基板(IC载板)与PCB的异同
封装基板与PCB的区别
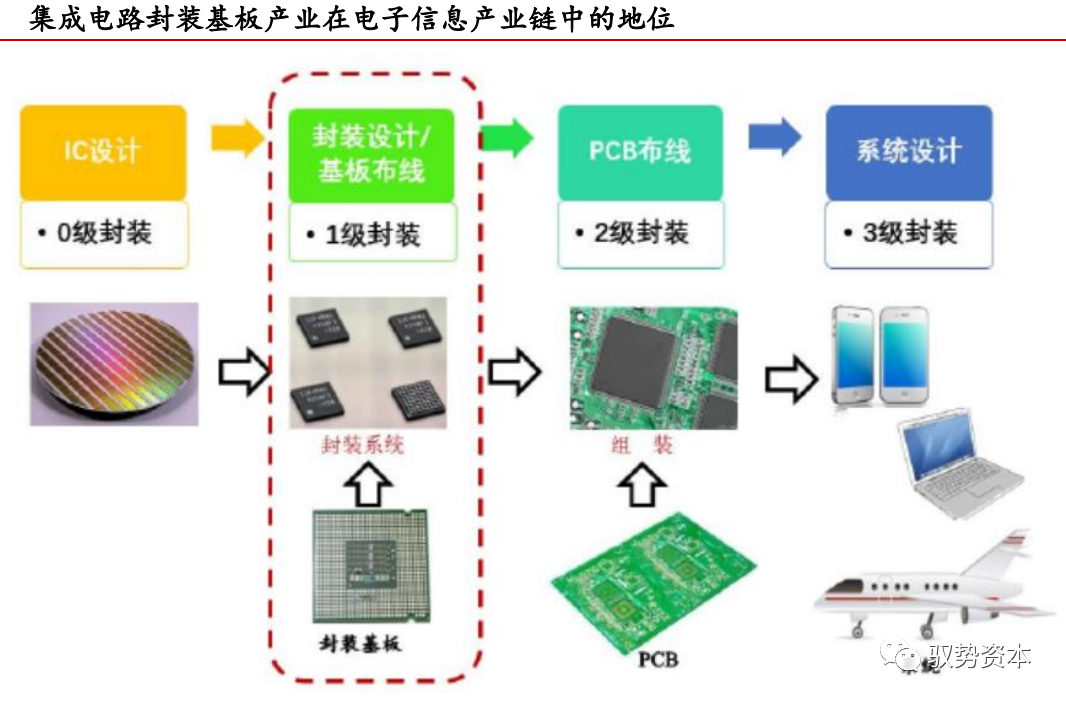
封装基板从PCB中分离独立出来的历程和原因
封装基板的主要结构和生产技术
有核和无核封装基板
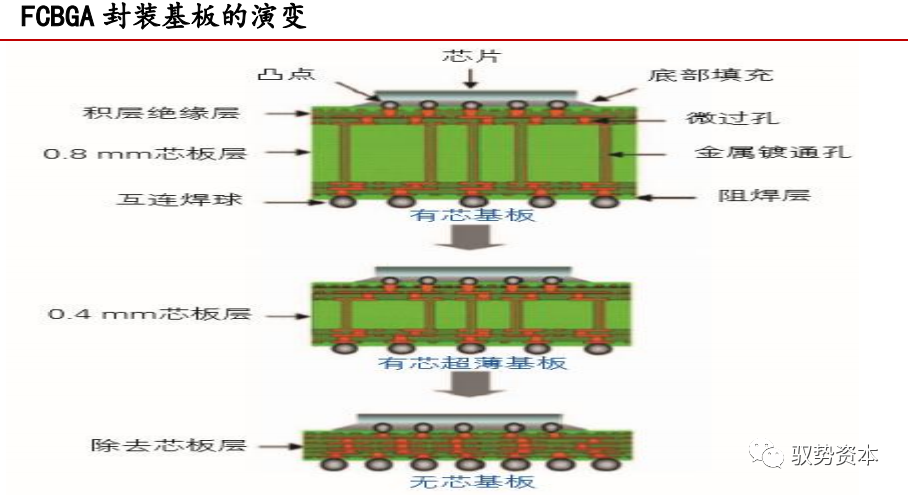
无核封装基板的优劣势
薄型化; 电传输路径减小,交流阻抗进一步减小,而且其信号线路有效地避免了传统有芯基板上的PTH(镀铜通孔)产生的回波损耗,这就降低电源系统回路的电感,提高传输特性,尤其是频率特性; 可以实现信号的直接传输,因为所有的线路层都可以作为信号层,这样可以提高布线的自由度,实现高密度配线,降低了C4布局的限制; 除部分制程外,可以使用原来的生产设备,且工艺步骤减少。
没有芯板支撑,无芯基板制造中容易翘曲变形,这是目前最普遍和最大的问题; 层压板破碎易于发生; 需要引进部分针对半导体封装无芯基板的新设备。因此,半导体封装无芯基板的挑战主要在于材料与制程。
封装基板的结构
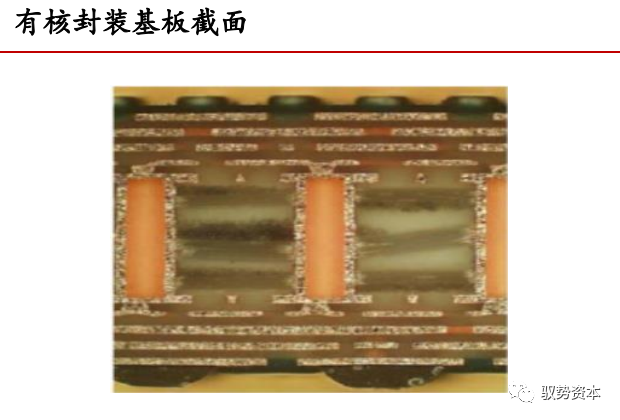
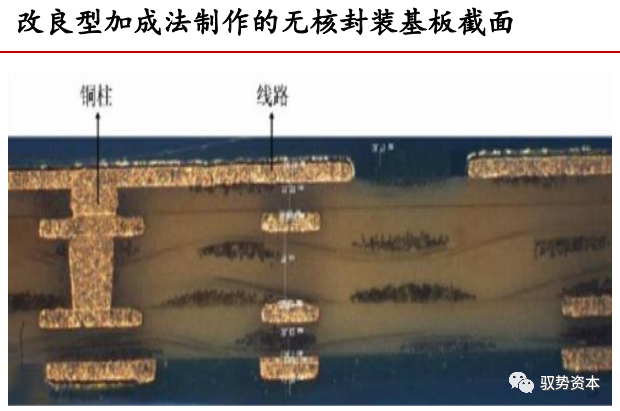
封装基板的主流生产技术
主要的积层精细线路制作方法
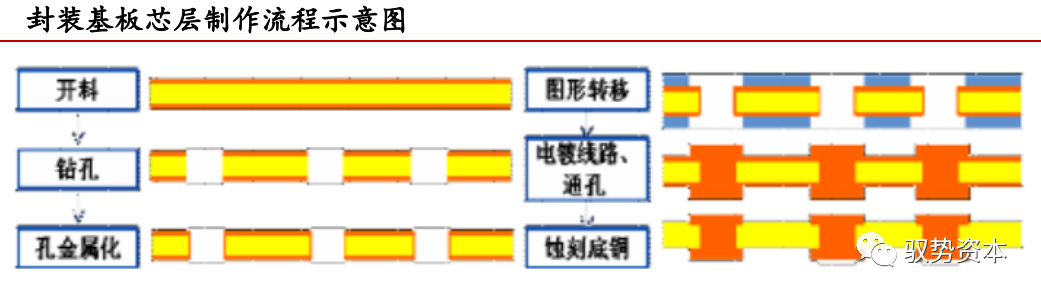
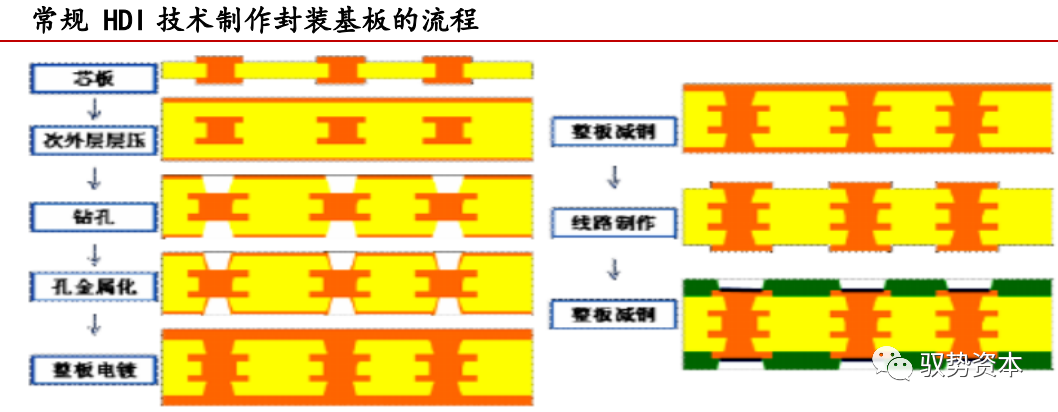
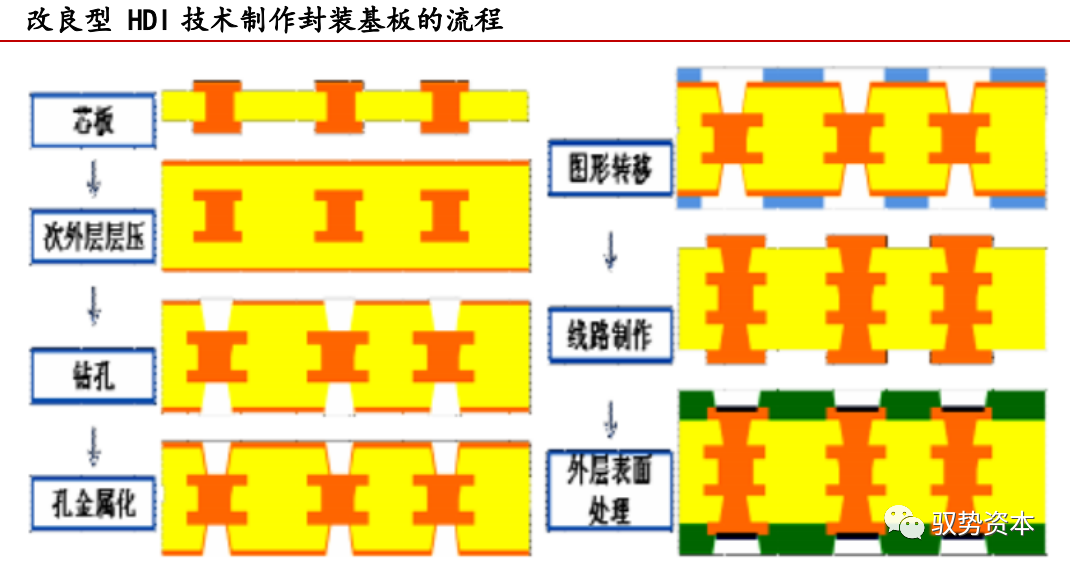
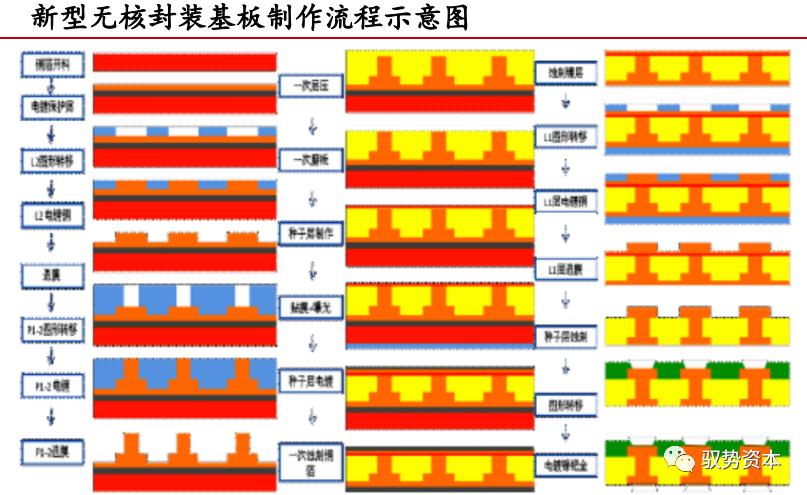
封装技术应用的演进
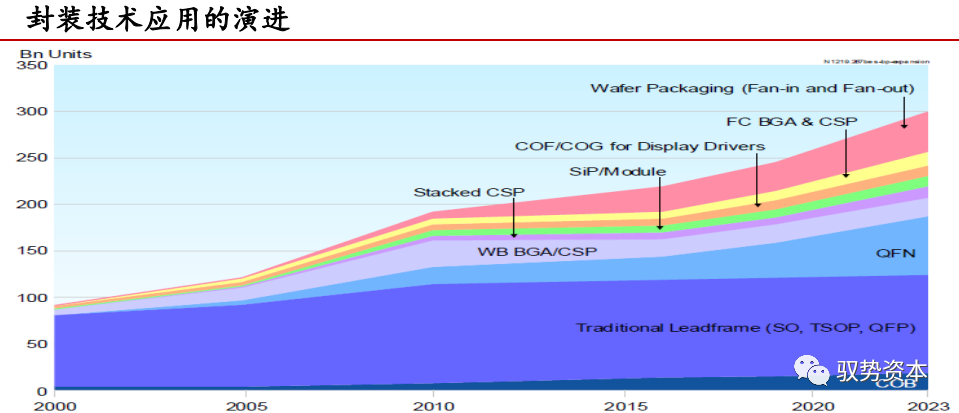
封装基板在晶圆制造和封装材料价值量占比最大

封装基板行业景气度的变化
有机和陶瓷封装基板是封装基板中的主流
全球地区分布


全球载板主要制造地及主要制造商现状


主流封装基板产品分类
主流封装基板产品市场规模和结构