1、减薄(Back Grind)(四川半导体设备公司):
芯片依工艺要求,需有一定之厚度。应用研磨的方法,达到减薄的目标。研磨的第一步为粗磨,第二步为细磨,目的为消减芯片粗磨中生成的应力破坏层(一般厚度为1~2μm左右)。
2、贴膜(Wafer Mount)
减薄之后,要在芯片背面贴上配合划片使用的蓝膜,才可开始划片。

3、划片(Wafer Saw)(四川半导体微组装设备:切片机)
划片时需控制移动划片刀的速度及划片刀的转速。不同芯片的厚度及蓝膜的黏性都需要有不同的配合的划片参数,以减少划片时在芯片上产生的崩碎现象。
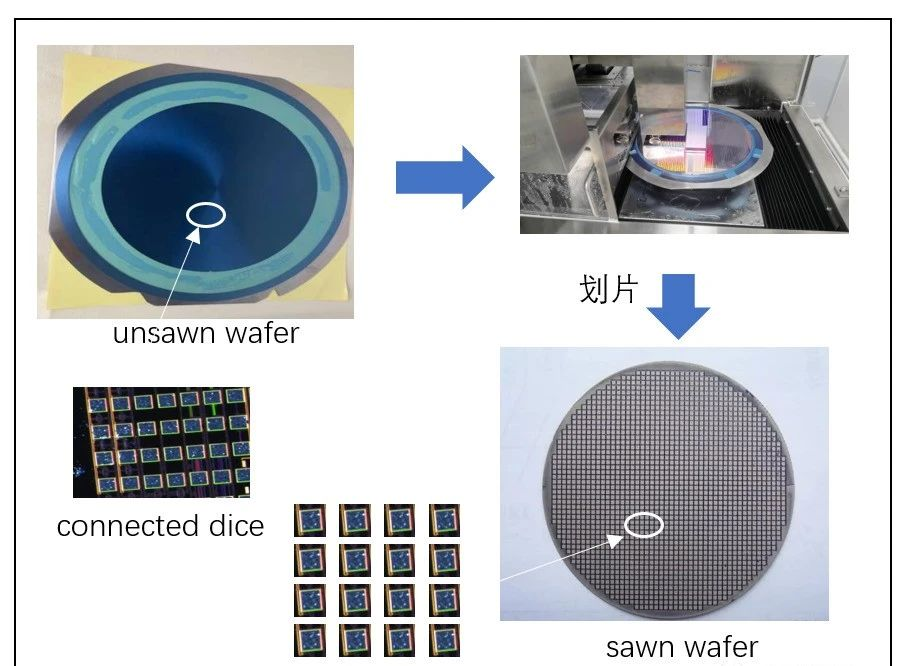
一般切割刀片可以达到最小的切割宽度为40μm左右。若用雷射光取代切割刀片可将切割宽度减小到20μm。所以使用窄小的切割道的特殊芯片必须用雷射光切割。对于厚芯片或堆叠多层芯片的切割方式,也建议使用雷射光切割。

一般划片时移动的速度为50mm/s。
一般划片时的刀片旋转的速率为38 000r/min。
划片完成后,还需要用洁净水冲洗芯片表面,保证芯片上打线键合区不会有硅粉等残留物,如此才能保证后序打线键合工艺的成功良品率。
4、贴片(Die Attach)(四川微组装设备:贴片机)
将芯片颗粒由划片后的蓝膜上分别取下,用胶水(epoxy)与支架(leadframe,引线筐架)贴合在一起,以便于下一个打线键合的工艺。

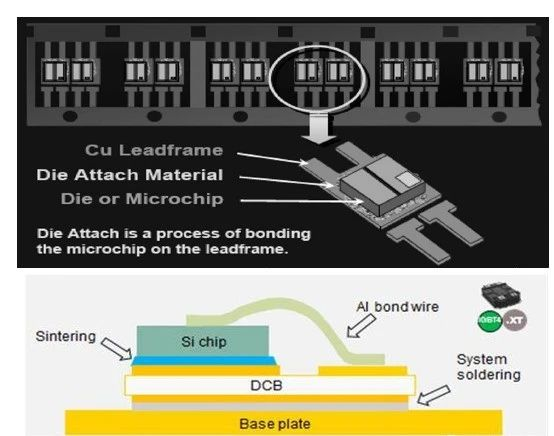
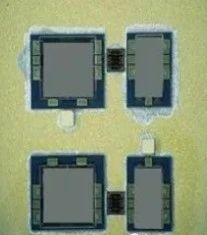
一般芯片颗粒背后银胶层厚度为5μm。同时芯片颗粒周边需要看到银胶溢出痕迹,保证要有90%的周边溢出痕迹。
其他的常用贴片模式之一,主要是使用共金熔焊模式取代银胶(见图7)。
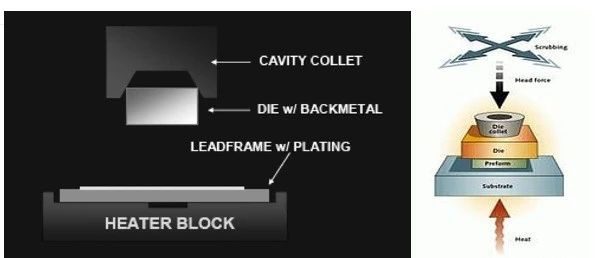
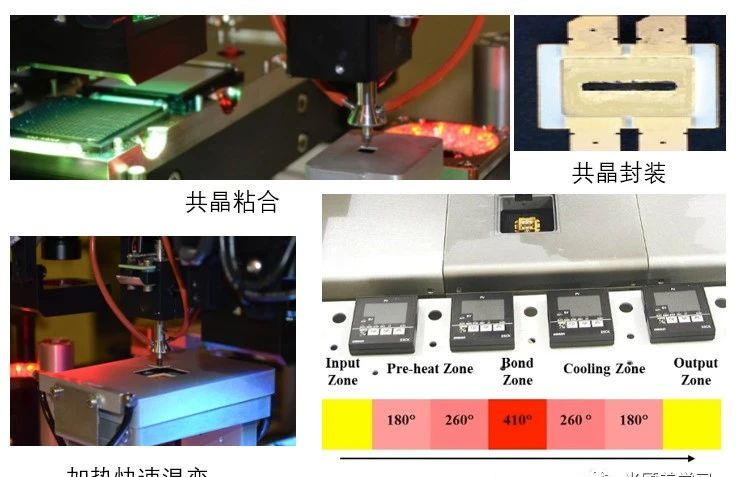
更多的四川半导体微组装设备资讯请联系:18980821008(张生)19382102018(冯小姐)
四川省微电瑞芯科技有限公司http://www.wdrx-semi.com/





