【摘要】氮化镓功率器件与硅基功率器件的特性不同本质是外延结构的不同,本文通过深入对比氮化镓HEMT与硅基MOS管的外延结构,再对增强型和耗尽型的氮化镓HEMT结构进行对比,总结结构不同决定的部分特性。此外,对氮化镓功率器件的外延工艺以及功率器件的工艺进行描述,加深对氮化镓功率器件的工艺技术理解。在理解氮化镓功率器件结构和工艺的基础上,对不同半导体材料的特性、不同衬底材料的氮化镓HEMT进行对比说明。(四川成都半导体微组装设备公司)
一、器件结构与制造工艺(四川半导体微组装设备自动化)
(一)器件结构对比
GaN HEMT是基于AlGaN/GaN异质结,目前市面上还未出现GaN的MOSFET,主要是因为同质GaN成本太高,一般采用Si或者SiC作为异质衬底,异质衬底就需要在衬底上生长一层缓冲层(AlN),而缓冲层是绝缘的,因此目前的GaN器件还没有MOSFET结构。
1、氮化镓HEMT与硅LDMOS的结构对比
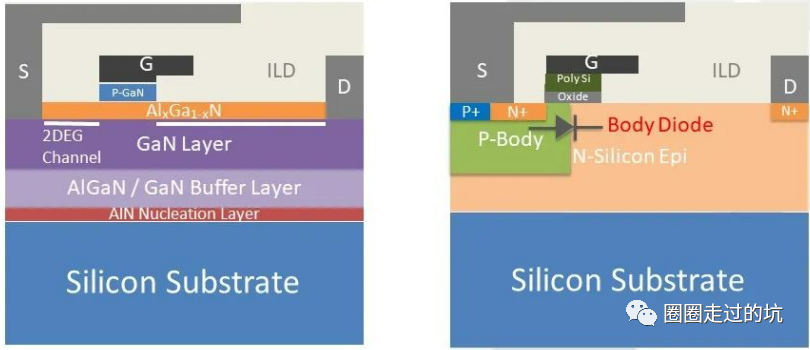
图1 GaN HEMT(增强型)VS 硅LDMOS结构
从结构看,氮化镓功率器件和硅LDMOS都是横向结构,即他们的源极(Source)、栅极(Gate)和漏极(Drain)都在芯片的上表面。同时为了让电场分布更加均匀,他们都使用了场板的设计。不同之处在于氮化镓是化合物半导体外延,通过异质结形成高电子迁移率的二维电子气沟道(2DEG)。而硅LDMOS是在硅外延层上进行掺杂形成P-N结。
2、氮化镓功率器件的结构(四川成都半导体设备)
氮化镓功率器件的外延结构可分为D-mode(Depletion-mode/耗尽型)和E-mode(Enhance-mode/增强型)。因为材料的极化特性,耗尽型是GaN功率器件的自然状态,增强型只能通过特殊工艺将其阈值电压从负值变成正值来实现。
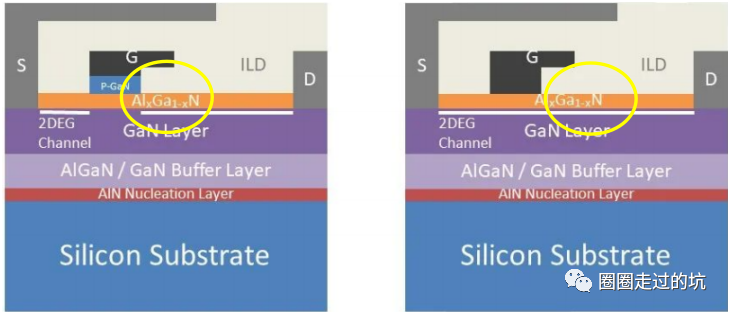
图2 E-Mode(增强型)GaN HEMT VS D-Mode(耗尽型)GaN HEMT
(1)D-mode/耗尽型结构
D-mode为常开型器件,在通常状态下(栅源极电压VGS=0),漏极和源极之间已存在2DEG,器件呈导通状态;当栅源极电压VGS<0时,漏、源极之间的2DEG断开,器件截止。在电力电子应用中,常开的器件在使用上不便且有安全方面的问题,因此D-mode氮化镓HEMT器件在应用中,经常级联/串联低压硅MOS一起使用,如下图所示。

图3 共源共栅GaN HEMT
D-mode氮化镓功率器件和低压MOSFET串联,共用栅极和源极,形成常关器件。
(2)E-mode/增强型
E-mode(Enhance-mode/增强型)为常关型,使用方式类似传统硅MOS,器件结构简单,适合高频化应用,增强型器件不需要负电压供电,实际应用中的氮化镓功率器件都需要是常关型的器件。
目前主流的增强型器件使用的P-GaN的工艺结构,这种工艺结构带来两类技术路线,对应两种商业模式。一类是以松下和英飞凌为代表的电流控制型。所谓电流控制,指的是门级驱动使用电流,而不是电压来控制。另外一类则是和硅MOS管以及碳化硅MOS管一样,使用门级电压驱动。

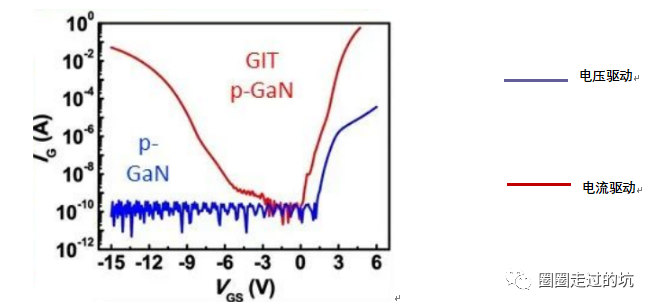
3、基本特性总结(四川成都微组装设备)
(1)氮化镓功率器件标准:650V
氮化镓功率器件的技术路线一般是650V,因为对于很多电源领域的应用,需要接入220V市电,母线电容上的电压在输入交流电压整流以后得到大约400V直流电压,再加上电压尖峰和部分拓扑结构应用中副边反射回来的电压,650V就成了一个标准的电压要求。
(2)没有雪崩击穿
没有雪崩击穿,一旦击穿,就是永久性的,类似于电容里面的介质击穿。对于650V的器件而言,如果是硅MOS管,一般实际击穿电压大约在750V左右(设计裕量10%),而氮化镓器件需要提供更高的电压设计裕量,650V器件至少需要900V以上的击穿电压(设计裕量>10%)。
(3)没有p型氮化镓管
硅基有NMOS(电子载流子)和PMOS(空穴载流子),但目前还没有p型GaN HEMT,因此模拟/数字IC的设计与硅不同。没有p型氮化镓管的原因主要是:首先,离子注入和镁离子低温退火在GaN上难以实现;其次,GaN的空穴迁移率只有30cm2/Vs,远低于2000cm2/Vs的电子迁移率。
(4)门级电压7V
氮化镓的工艺决定,氮化镓功率器件的最大门级电压被限制在了7V,且于现有的硅驱动IC不兼容。
(二)器件工艺技术
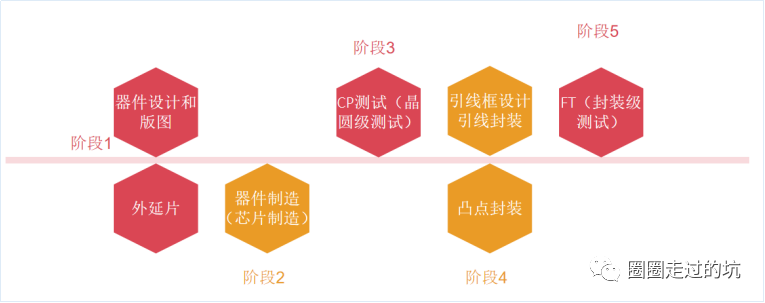
2、外延片制造流程
氮化镓外延片可在硅衬底、碳化硅衬底或蓝宝石衬底上进行生长,从成本和大批量生产考虑,外延的每一层的沉积一般采用MOCVD(金属氧化物化学气相沉积)。
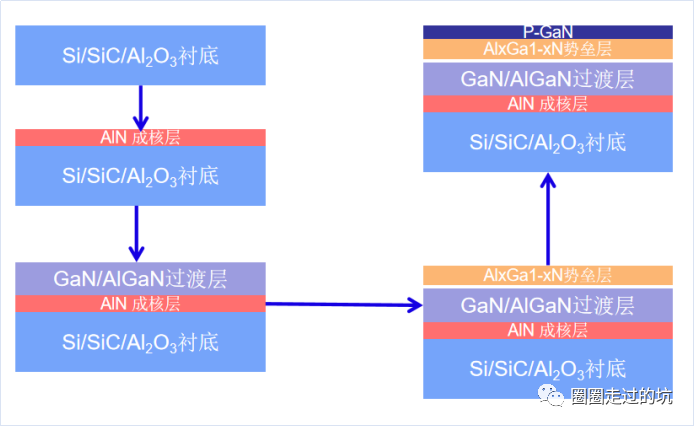
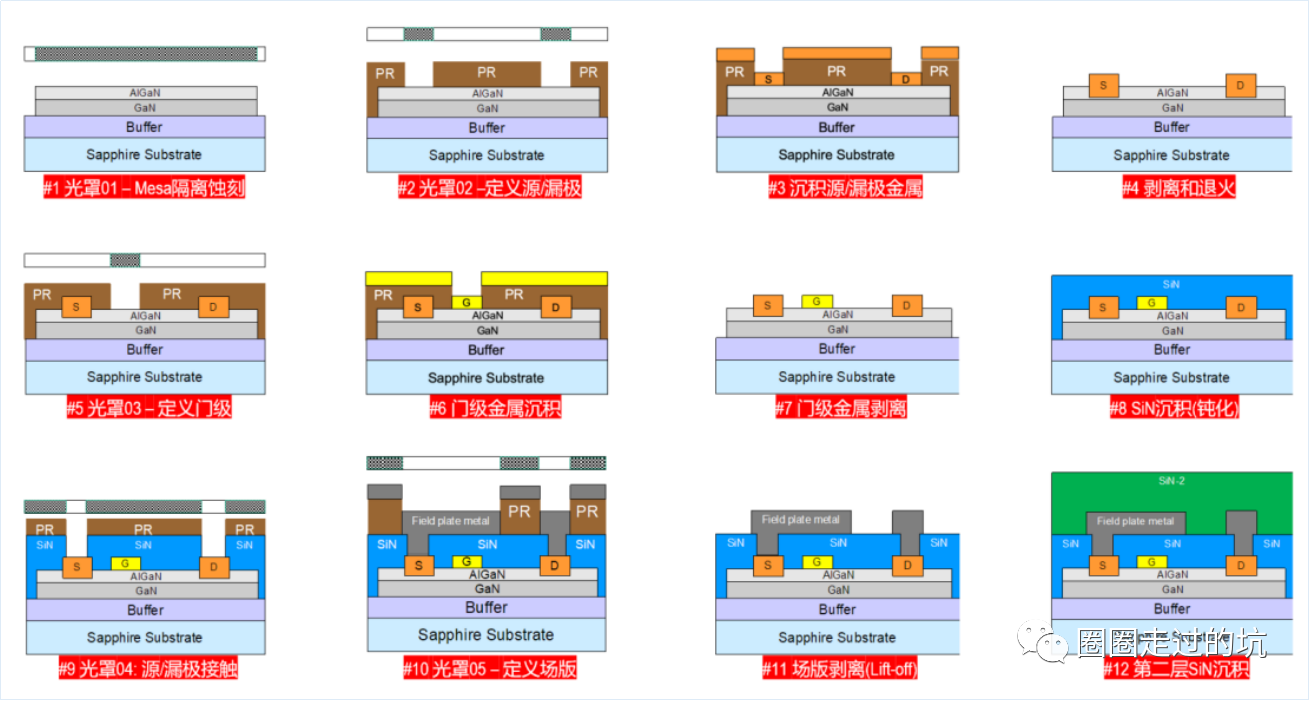
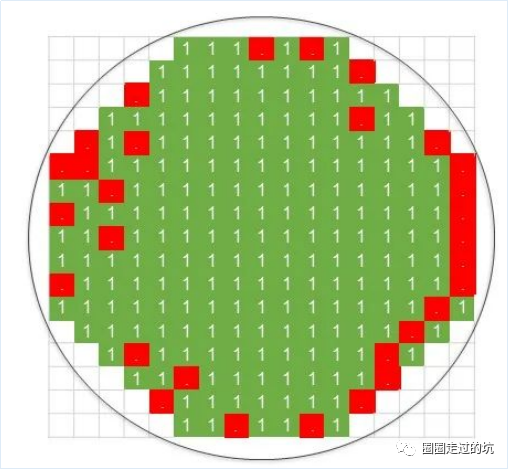

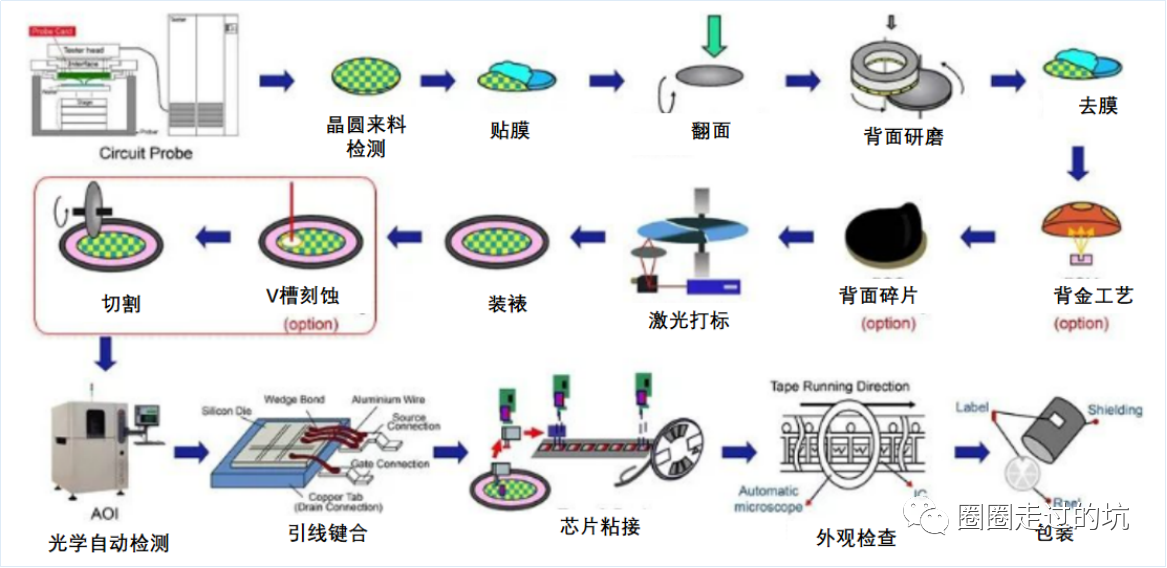
二、器件的材料对比

(二)衬底材料的Ga HEMT对比(四川半导体清洗设备)

因为氮化镓HEMT结构是外延结构,衬底可使用不同的材料。
更多的四川半导体微组装设备资讯请联系:18980821008(张生)19382102018(冯小姐)
四川省微电瑞芯科技有限公司http://www.wdrx-semi.com/





