光刻胶是由可溶性聚合物和光敏材料组成的化合物,当其暴露在光线下时,会在溶剂中发生降解或融合等化学反应。在运用于晶圆级封装的光刻(Photolithography)工艺过程中时,光刻胶可用于创建电路图案,还可在后续电镀(Electroplating)¹过程中通过电镀金属丝以形成阻挡层。光刻胶的成分如图1所示。(四川成都半导体微组装设备公司)
¹电镀(Electroplating):一项晶圆级封装工艺,通过在阳极上发生氧化反应来产生电子,并将电子导入到作为阴极的电解质溶液中,使该溶液中的金属离子在晶圆表面被还原成金属。

³g线(g-line):在汞光谱中,一条对应波长约为436纳米的谱线。
⁴i线(i-line):在汞光谱中,一条对应波长约为356纳米的谱线。
⁵化学放大型抗蚀剂(CAR):一种用于提高光刻胶材料光敏性的抗蚀剂。
⁶步进式光刻机(Stepper):用于曝光晶圆的设备。不同类型的设备用于不同精度晶圆的曝光,具体取决于对应的光源类型。
电镀液:由金属离子、酸和添加剂组成,用于可控电镀工艺
电镀液(Plating Solution)是一种在电镀过程中使用的溶液,由金属离子、酸和添加剂组成。其中,金属离子是电镀过程中的待镀物质;酸作为溶剂,用于溶解溶液中的金属离子;多种添加剂用于增强电镀液和镀层的性能。可用于电镀的金属材料包括镍、金、铜、锡和锡银合金,这些金属以离子的形式存在于电镀液中。常见的酸性溶剂包括硫酸(Sulfuric Acid)和甲磺酸(Methanesulfonic Acid)。添加剂包括整平剂(Leveler)和细化剂(Grain Refiner),其中,整平剂用于防止材料堆积,提高电镀层平整性;而晶粒细化剂则可以防止电镀晶粒的横向生长,使晶粒变得更加细小。
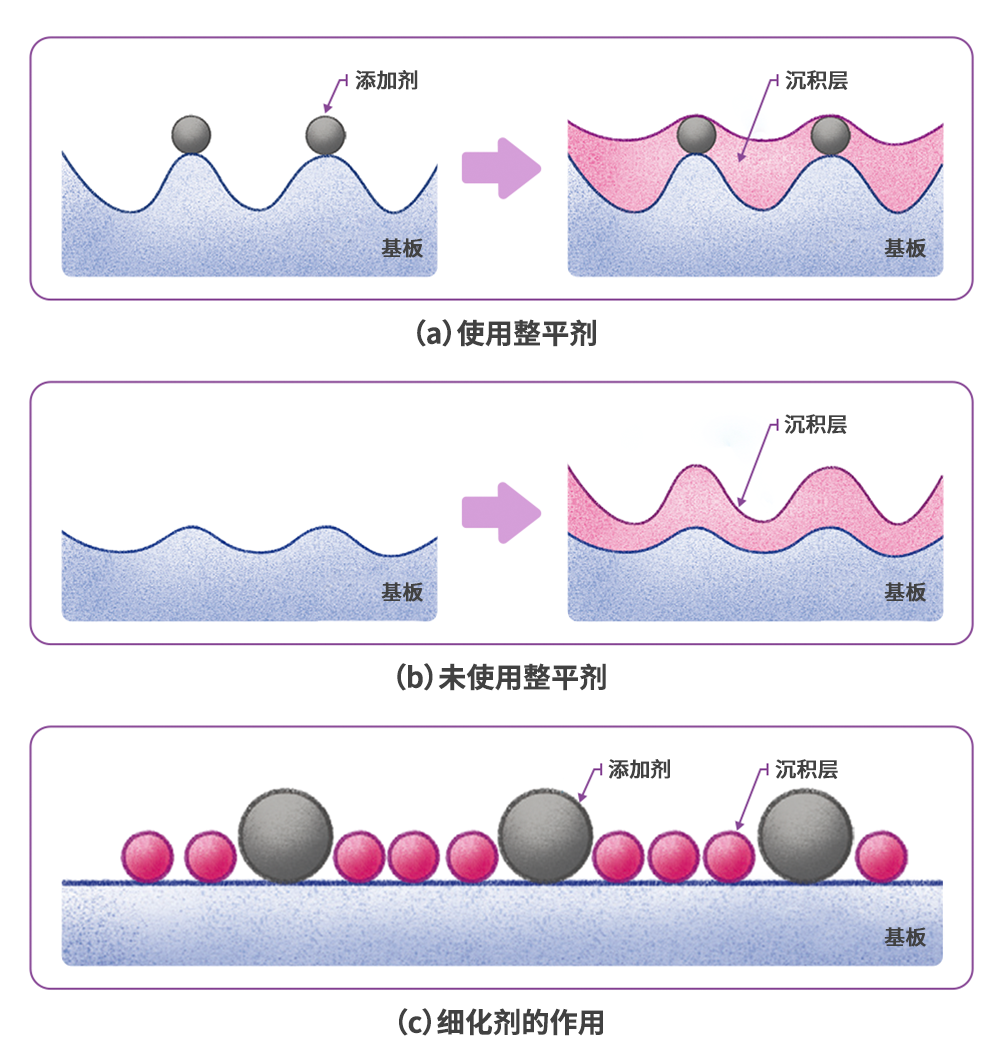
▲ 图2:电镀液中添加剂的作用(ⓒ HANOL出版社)
光刻胶剥离液(PR Stripper):使用溶剂完全去除光刻胶
电镀工艺完成后,需使用光刻胶剥离液去除光刻胶,同时注意避免对晶圆造成化学性损伤或产生残留物。图3展示了光刻胶去胶工艺的过程。首先,当光刻胶剥离液与光刻胶表面接触时,两者会发生反应,使光刻胶膨胀;接下来,碱性剥离液开始分解并溶解膨胀的光刻胶。(四川成都半导体微组装设备自动化)
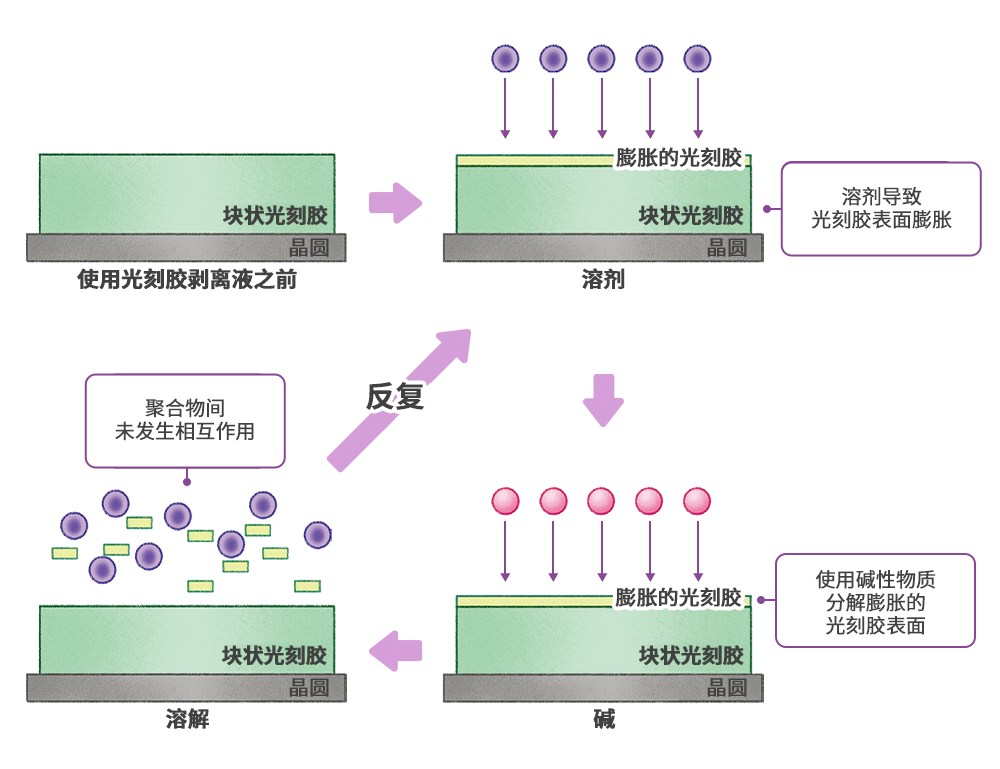
▲ 图3:光刻胶剥离液的去胶工序(ⓒ HANOL出版社)
刻蚀剂:使用酸、过氧化氢等材料精确溶解金属
图4展示了刻蚀剂的主要成分和作用。根据不同的待溶解金属,可选用不同刻蚀剂,如铜刻蚀剂、钛刻蚀剂、银刻蚀剂等。此类刻蚀剂应具有刻蚀选择性——在有选择性地溶解特定金属时,不会溶解或仅少量溶解其它金属;刻蚀剂还应具备较高的刻蚀速率,以提高制程效率;同时还应具备制程的均匀性,使其能够均匀地溶解晶圆上不同位置的金属。

▲ 图4:刻蚀剂的主要成分和作用(ⓒ HANOL出版社)
溅射靶材:将金属沉积于基板上
溅射靶材是一种在物理气相沉积(PVD)⁸过程中,采用溅射工艺在晶圆表面沉积金属薄膜时使用的材料。图5展示了靶材的制造工序。首先,使用与待溅射金属层成分相同的原材料制成柱体;然后经过锻造、压制、和热处理最终形成靶材。(四川有哪些半导体微组装设备厂家?)
⁸物理气相沉积(PVD):一种采用物理方法将材料分离并沉积在特定表面的薄膜沉积工艺。

▲ 图5:溅射靶材的制作工序(ⓒ HANOL出版社)
在预填充过程中,芯片级封装和晶圆级封装采用的填充方法也有所不同。对于芯片级封装,会根据接合处的填充物,如非导电胶(NCP)或非导电膜(NCF),根据不同的填充物,其采用的工艺和材料也不尽不同;而对于晶圆级封装,非导电膜则被作为底部填充的主材。图6说明了不同类型的底部填充材料和相关工序。
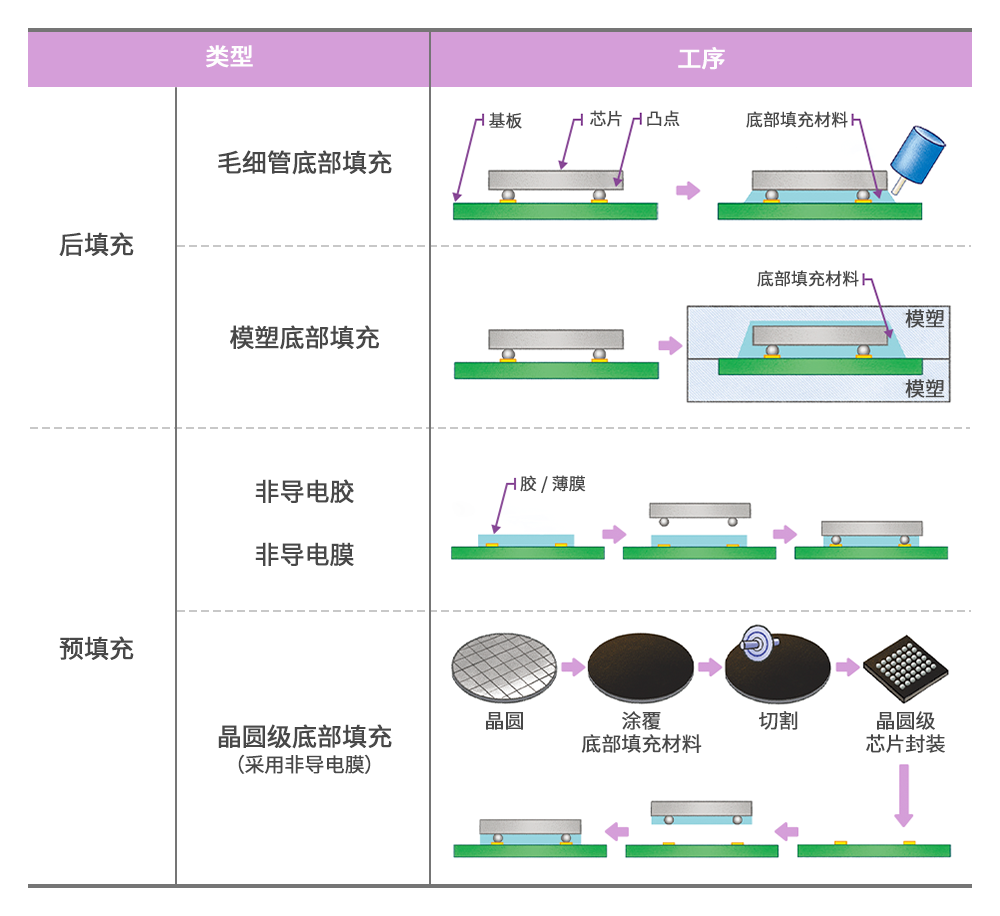
▲ 图6:不同类型的底部填充工艺(ⓒ HANOL出版社)
晶圆承载系统:使用载片、临时键合胶(TBA)、承载薄膜(Mounting tape)实现封装组装
¹¹排气(Outgassing):气体从液体或固体物质中释放出来。如果这种气体凝结在半导体器件表面,并对器件性能产生影响,则会导致半导体器件存在缺陷。
¹²空隙(Voids):因气泡的存在,在材料内部形成的空隙,有可能在高温工艺或脱粘过程中会膨胀,增加使器件发生损坏或故障的风险。
¹³分层(Delamination):半导体封装中两个相连的表面互相分离的现象。
更多的四川半导体微组装设备资讯请联系:18980821008(张生)19382102018(冯小姐)
四川省微电瑞芯科技有限公司http://www.wdrx-semi.com/





