在之前,有人曾表示,混合键合将成为自 EUV 以来半导体制造最具变革性的创新。事实上,它将对设计流程产生比 EUV 本身更大的影响,从封装架构延伸到单元设计和布局。知识产权生态系统将发生巨大重塑,制造流程也将发生巨大重塑。2D 晶体管缩小的时代仍将继续,但步伐缓慢,但混合键合将带来芯片设计者思考 3D 的新时代。(四川半导体微组装设备公司)
但semianalysis却表示,随着这句充满炒作的谣言结束,我们应该注意到,将混合键合技术大规模推向市场存在许多重大的工程和技术挑战,因为如今它仅保留给少数 AMD 芯片、CMOS 图像传感器和一些供应商的 3D 芯片和NAND。这种转变将重塑供应变化和设计流程。
在这里,我们编译了semianalysis的科普文章,带大家进一步了解这个技术。
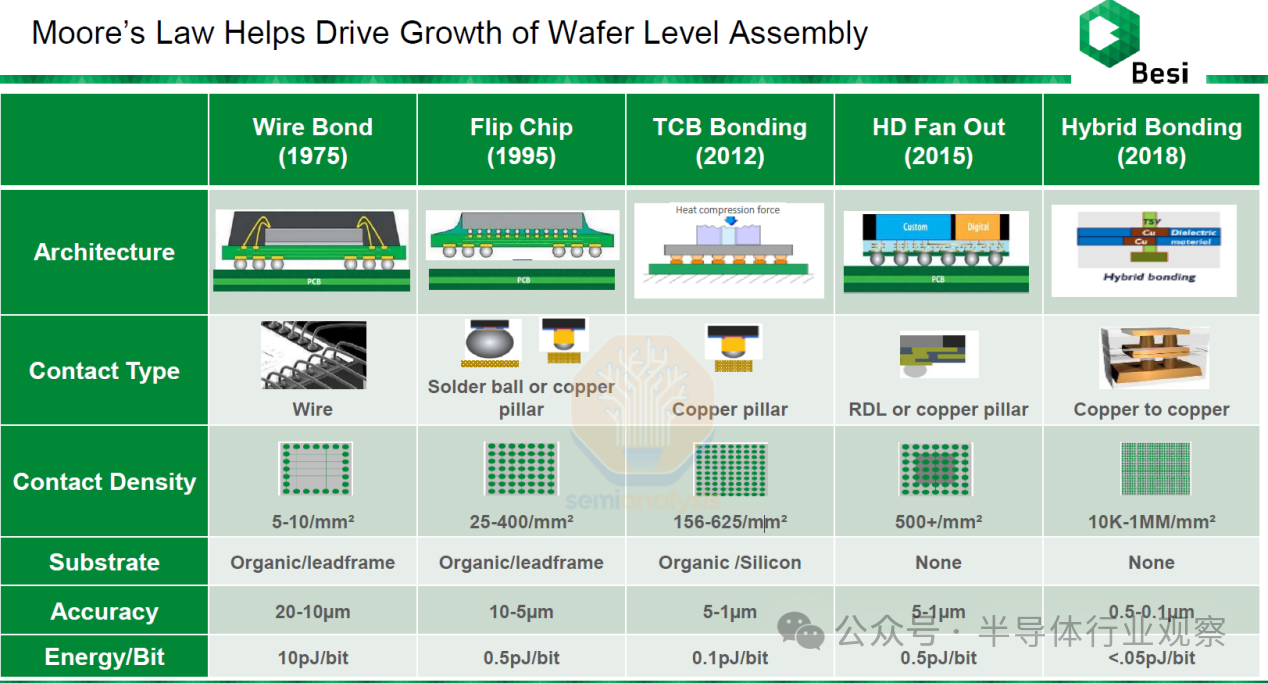
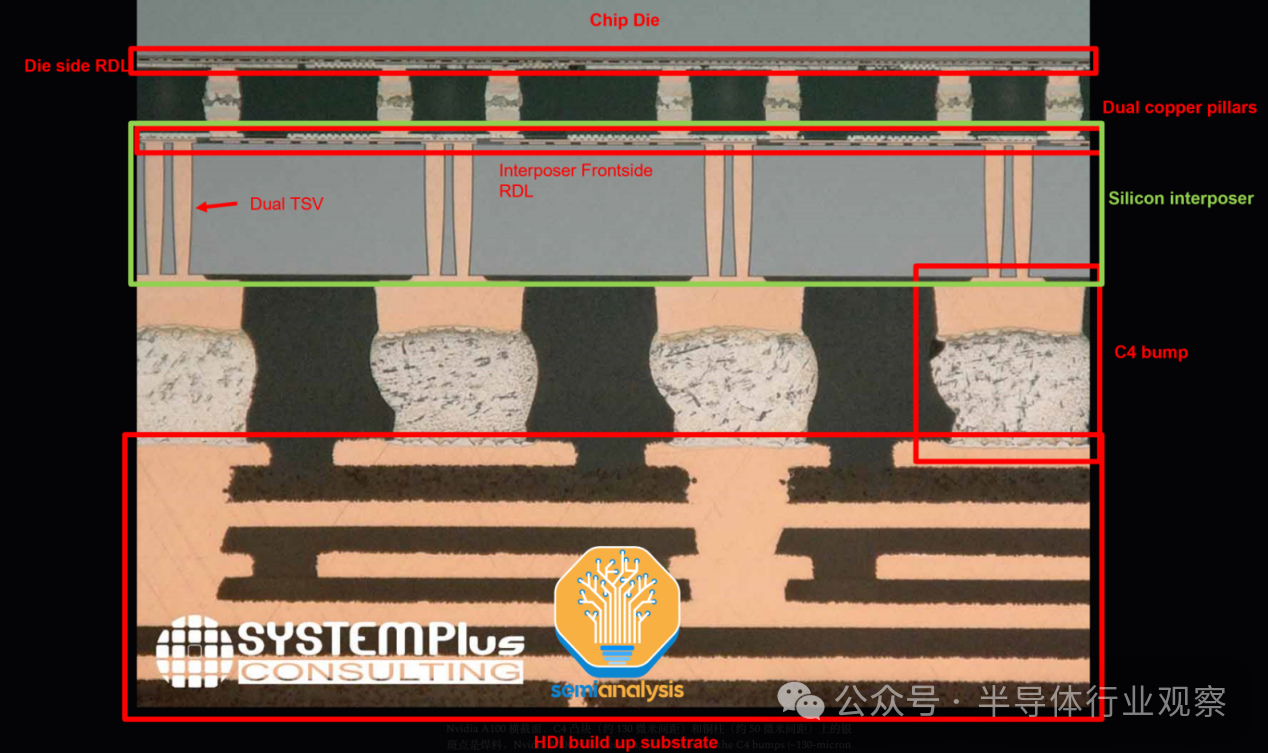
混合键合到底是什么?
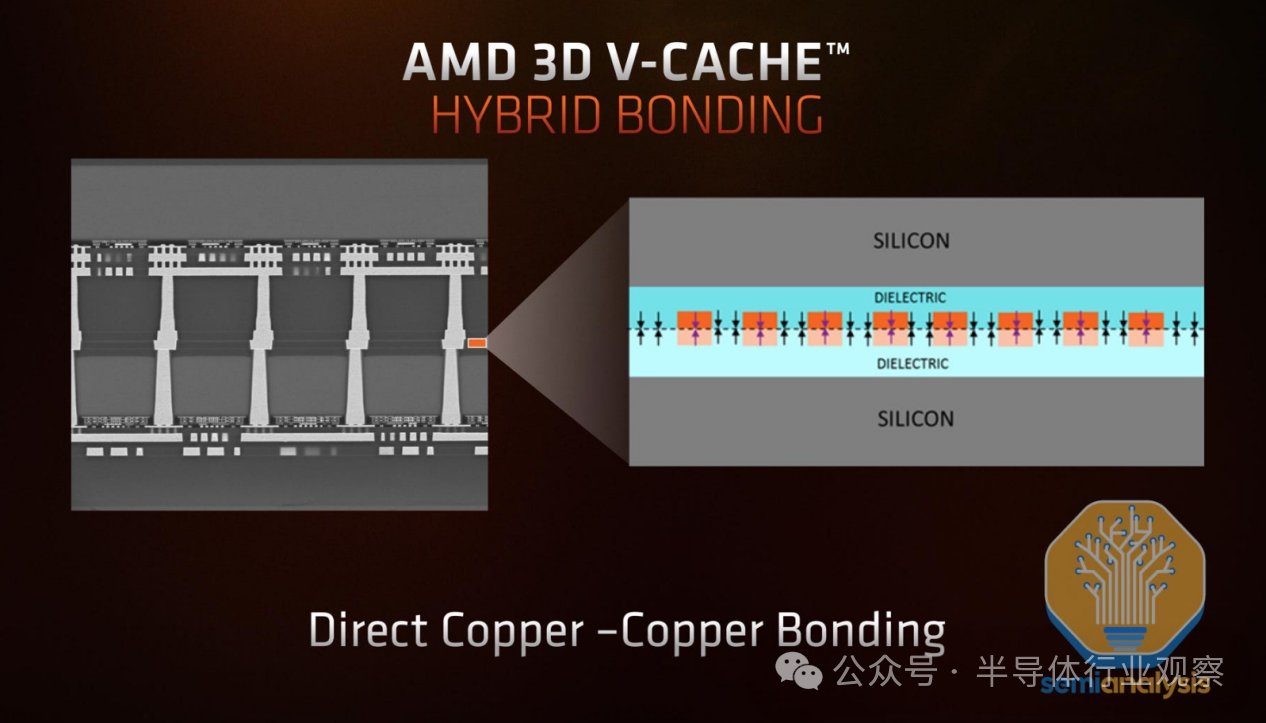
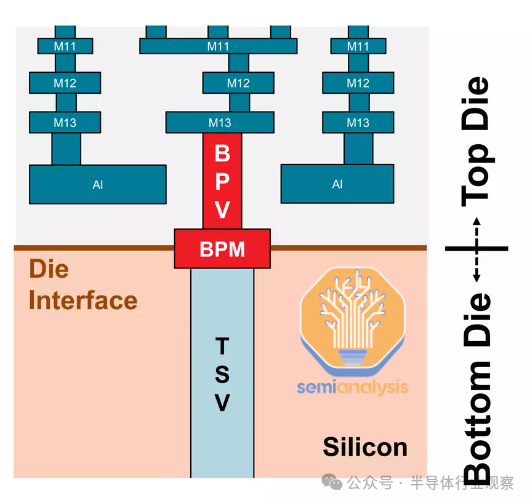
关键工艺条件
颗粒和清洁度



光滑度
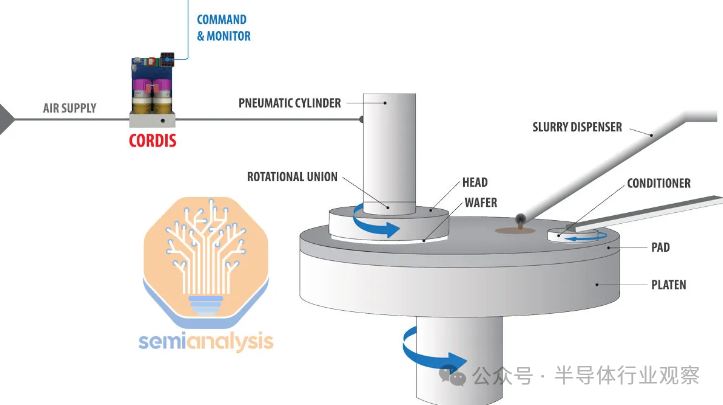
晶圆到晶圆(W2W)或芯片到晶圆(D2W)
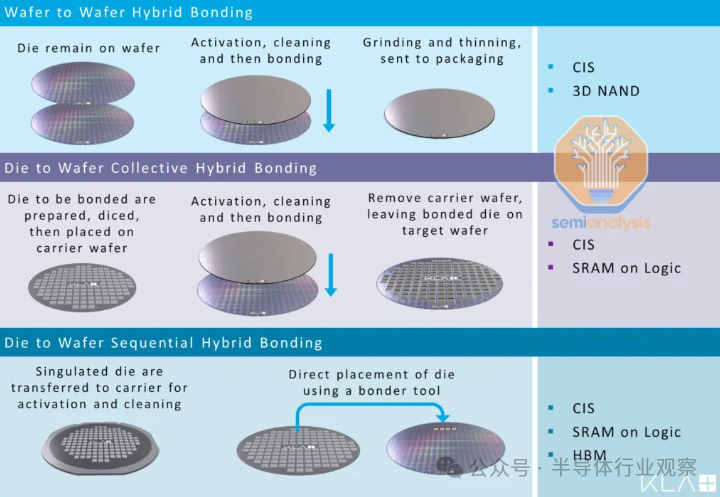


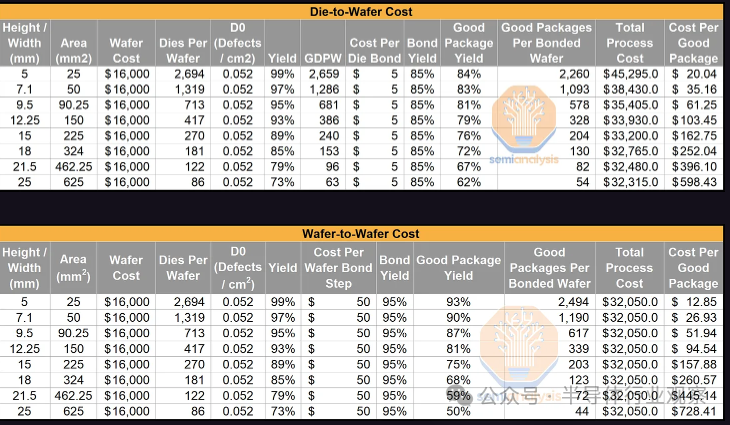
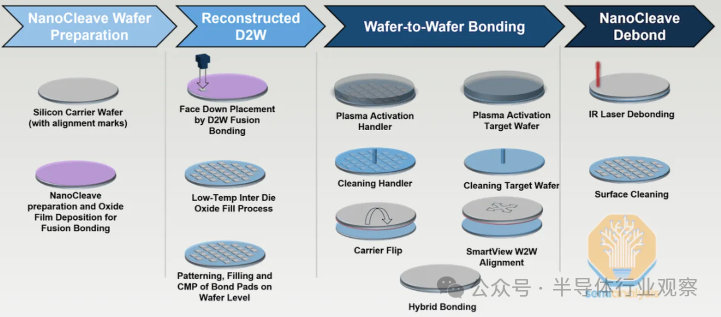

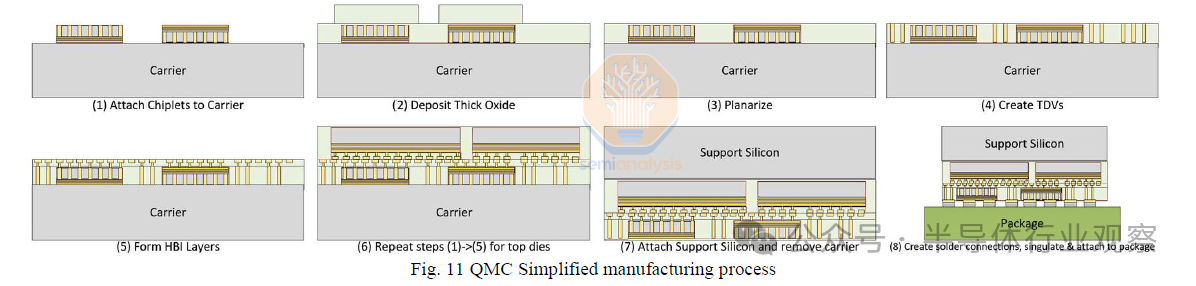
混合键合工艺流程


1.TSV形成
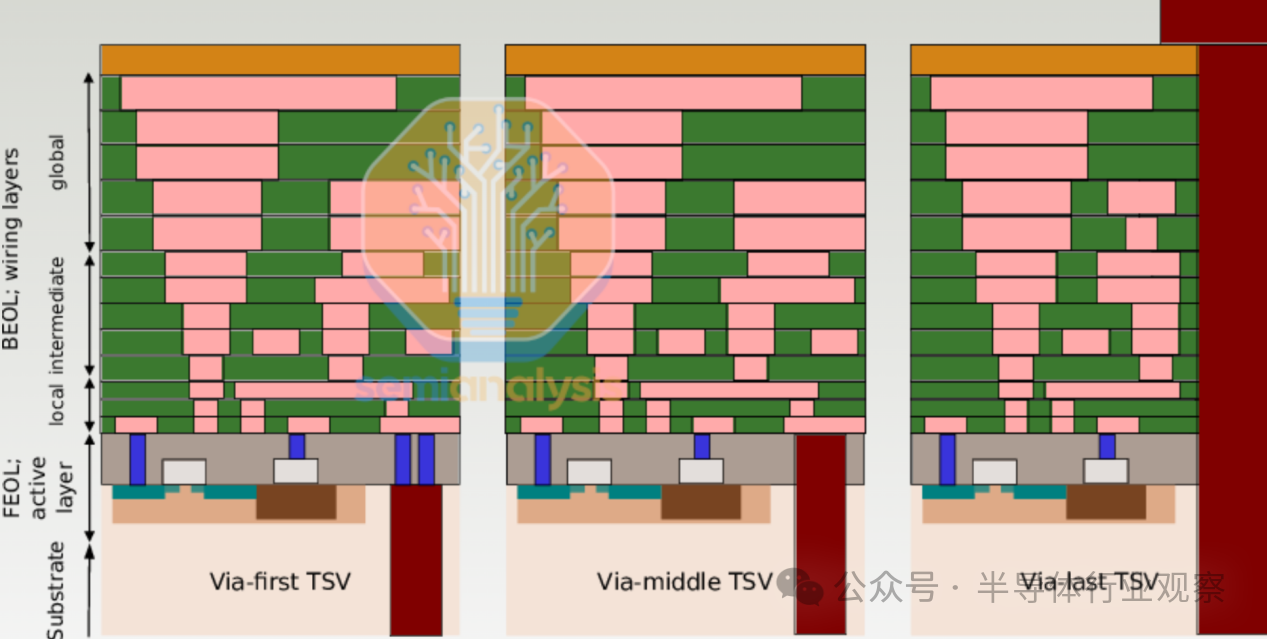
2.混合键层形成
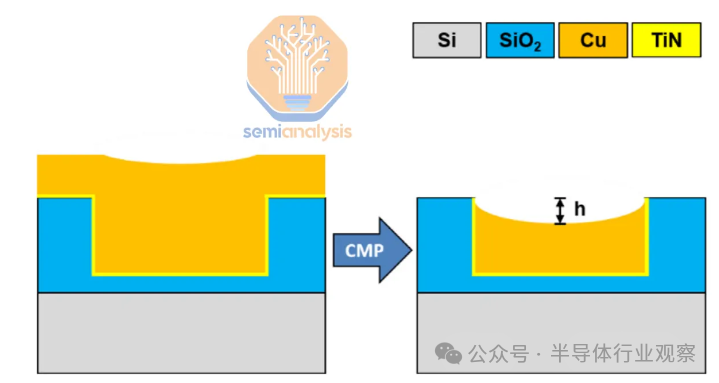
3.晶圆分类/分割
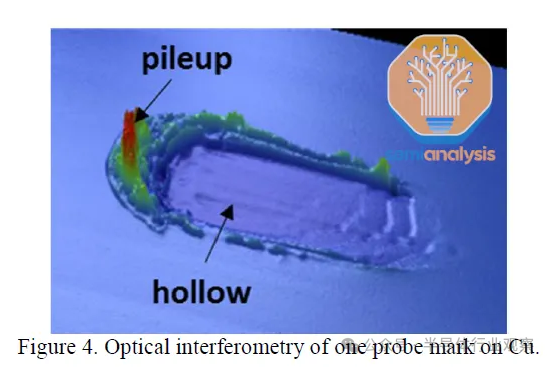
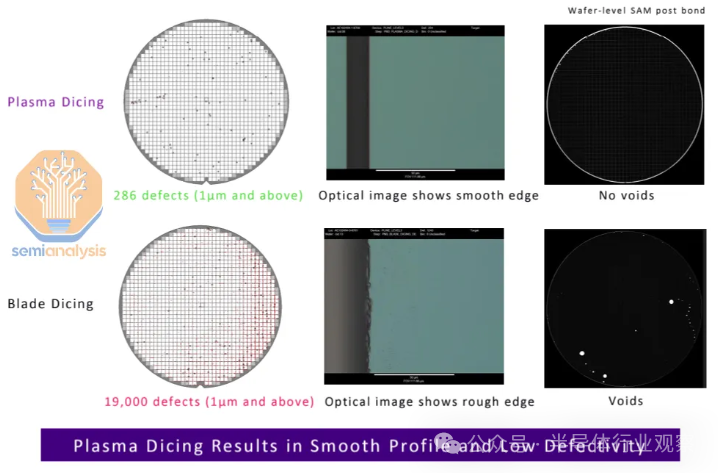
4.等离子激活和清洁
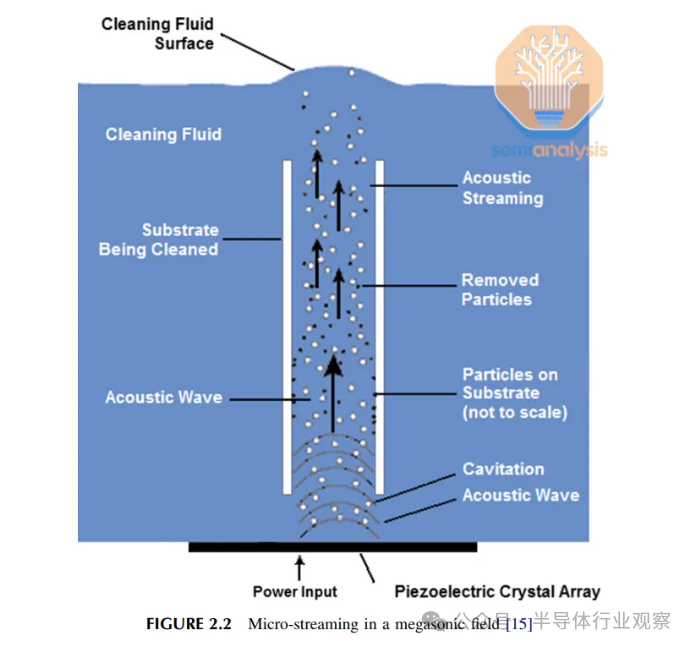
5.键合Bonding
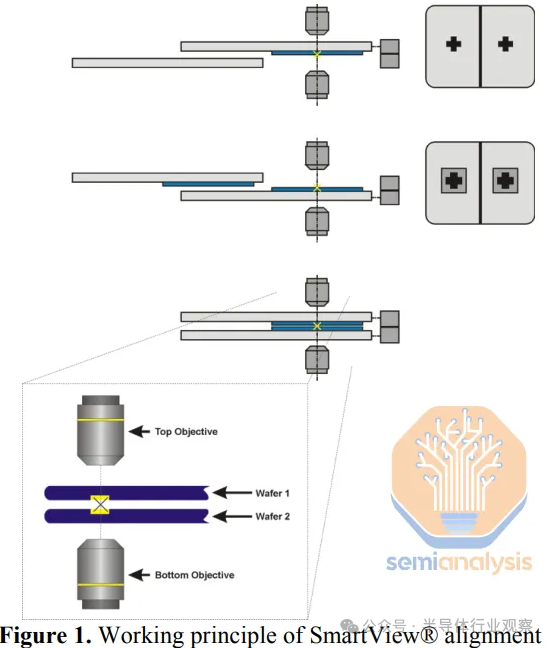
更多的四川半导体微组装设备资讯请联系:18980821008(张生)19382102018(冯小姐)
四川省微电瑞芯科技有限公司http://www.wdrx-semi.com/





