键合(四川微组装有哪些?)金丝需要在150度的温度条件下进行键合,在键合过程中,金丝与铝焊盘不可避免地形成金属间化合物(IMC,Intermetallic Compound)。从物理性能上评估,IMC具有更高的电阻率以及不同的晶格类型,意味着IME的存在会降低键合界面的键合强度和导电性能;从键合工艺来讲,引线键合工艺的实质是在芯片与引线之间在范德华力的作用下通过原子互扩散来实现金丝与铝焊盘在原子量级上的键合。因此界面化合物的形成会增加键合点的脆性和阻值,从而影响键合器件的电气性能以及长期寿命。(四川半导体设备公司)
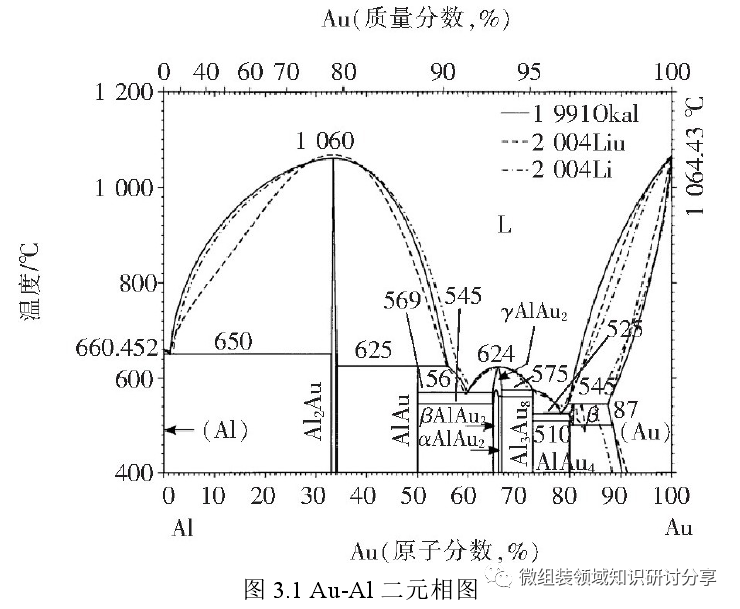
由Au-Al相图可知,在金丝键合界面可能形成以下五种化合物。由Au-Al界面化合物的物理性能可以发现,IMC的晶格类型和晶体结构与Au、Al原子存在差异,并且拥有较差的物理性能和电学指标,从微观上看,IMC的存在会使得键合界面出现大量的位错,导致界面脆性增强;从宏观上看,IMC的形成会导致键合点接触电阻增大,由于热膨胀系数的差异会出现热失配现象,在服役期间容易出现开裂等失效现象。
引线键合过程中键合丝和金属焊盘都没有融化,而且没有第三种物质参与,因此引线键合技术的实质是固相焊接。首先,利用超声能量使得焊盘表面的氧化层破裂,建立金和铝的扩散通路,在热应力和机械应力的作用下,促使键合界面的互扩散以实现键合丝和金属焊有效焊接。(四川成都半导体厂家)
在接合处进行固相焊接的基本过程:1)在外部机械应力和热应力的作用下,金属焊盘表面的氧化膜被破坏,局部接触点发生塑性变形,形成许多微小的焊点。2)在连续应力的作用下,两者之间的接触面积逐渐扩大,连接区域越来越多。3)金和铝由于高温的作用,原子彼此扩散,空洞变小,晶界移动;4)中间层继续生长,未连接区域消失,形成可靠的宏观焊点。

从理论层面上分析表明,当键合金丝和铝焊盘相互靠近,距离达到原子大小的量级(0.1nm级)时,它们就会在原子间作用力的相互吸引作用下形成良好接触并拥有一定的接合强度。
但在实际应用中,存在着两个问题:从微观角度看,焊盘的表面不可能做到绝对平整,它的平整度在0.01um量级,与上述可实现良好结合的距离相差两个数量级,因此很难保证一个平面全部实现良好接触;由于键合丝和芯片焊盘都要在大气环境中长时间的存放,因此在铝焊盘表面都有一层致密的氧化层,金丝由于表面能较高会吸附大气中的水分等杂物在表面形成一层附加层。氧化层和附加层一方面可以很好地保护金属材料,隔绝内部金属材料与外部环境的接触,防止外部环境对内部材料的进一步消耗,另一方面也会严重阻碍两种材料的连接,因为氧化层是由化合物分子构成,相互接触不会产生相互作用力。为了实现键合丝和芯片焊盘的良好结合,必须去除铝焊盘上的氧化铝薄膜。(四川微组装自动化)
根据金、铝的变形机理可行,在150度以上的温度条件、键合压力在几十牛的工艺参数下,主要变形模式是位错滑移。
在键合过程中,在键合压力的作用下,金丝和铝焊盘形成局部接触;在热应力和超声能量的共同作用下,铝焊盘上的氧化铝薄膜和键合金丝的表面结构被破坏,在键合压力的作用下,在两者表面发生位错增殖,使得金丝和铝焊盘表面的氧化膜破碎,实现两种金属的接触,发生原子扩散。在键合界面处,浓度差、化学势梯度和外应力的存在促进了Au原子和Al原子进行相互扩散,宏观体现为IMC层向金丝侧生长。
更多的四川微组装设备资讯请联系:18980821008(张生)19382102018(冯小姐)
四川省微电瑞芯科技有限公司http://www.wdrx-semi.com/





