
沾污源与控制
1>. 空气
2>. 人
3>. 厂房
4>. 水
5>. 工艺用化学品
6>. 工艺气体
7>. 生产设备
沾污控制
1.净化间布局
2.气流原理
3.空气过滤
4.温度和湿度
5.静电释放
厂房布局

气流原理
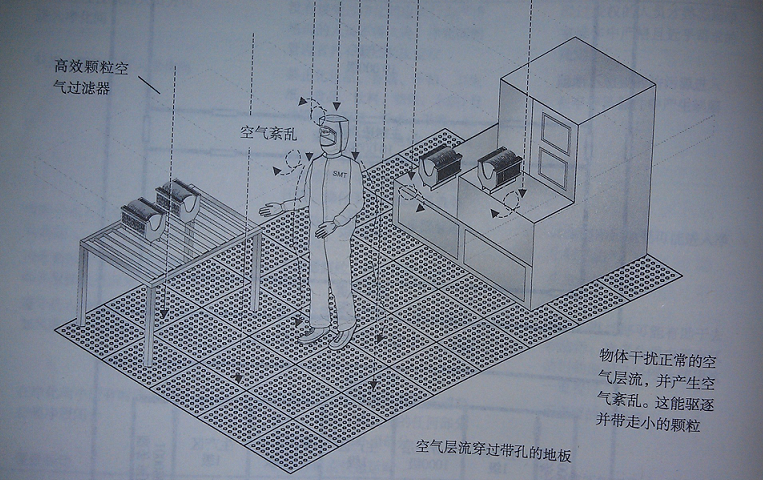
微环境
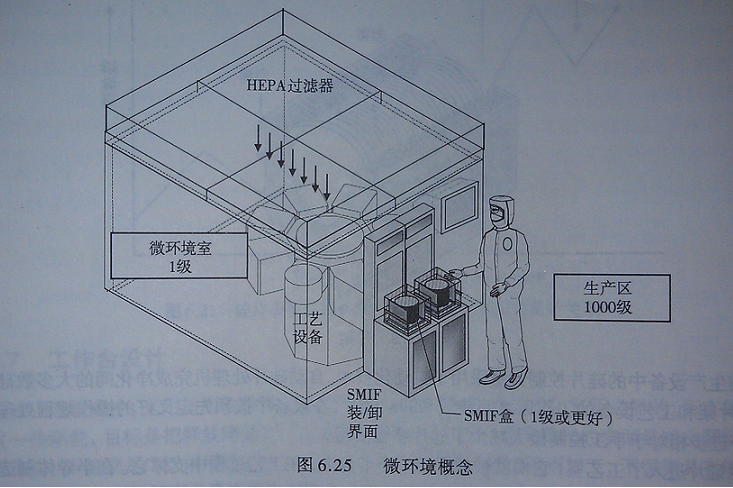
硅片清洗方法分类
①湿法清洗
湿法清洗采用液体化学溶剂和DI水氧化、蚀刻和溶解晶片表面污染物、有机物及金属离子污染。通常采用的湿法清洗有RCA清洗法、稀释化学法、 IMEC清洗法、单晶片清洗等.
②干法清洗
干法清洗采用气相化学法去除晶片表面污染物。气相化学法主要有热氧化法和等离子清洗法等,清洗过程就是将热化学气体或等离子态反应气体导入反应室,反应气体与晶片表面发生化学反应生成易挥发性反应产物被真空抽去。@微电瑞芯,您身边的专业设备供应商。四川半导体清洗机,四川等离子清洗机,西南半导体 请认准微电瑞芯科技有限公司
硅片湿法清洗化学品
沾污 | 名称 | 化学配料描述 (所有清洗随后伴随去离子水清洗) | 化学分子式 |
颗粒 | Piranha(SPM) | 硫酸/过氧化氢/去离子水 | H2SO4/H2O2/H2O |
SC-1 (APM) | 氢氧化铵/过氧化氢/去离子水 | NH4OH/ H2O2/H2O | |
有机物 | SC-1 (APM) | 氢氧化铵/过氧化氢/去离子水 | NH4OH/ H2O2/H2O |
金属(不含铜) | SC-2 (HPM) | 盐酸/过氧化氢/去离子水 | HCL/ H2O2/H2O |
Piranha(SPM) | 硫酸/过氧化氢/去离子水 | H2SO4/ H2O2/H2O | |
DHF | 氢氟酸/水溶液(不能去除铜) | HF/ H2O | |
自然氧化层 | DHF | 氢氟酸/水溶液(不能去除铜) | HF/ H2O |
BHF | 缓冲氢氟酸 | NH4F/ HF/ H2O |

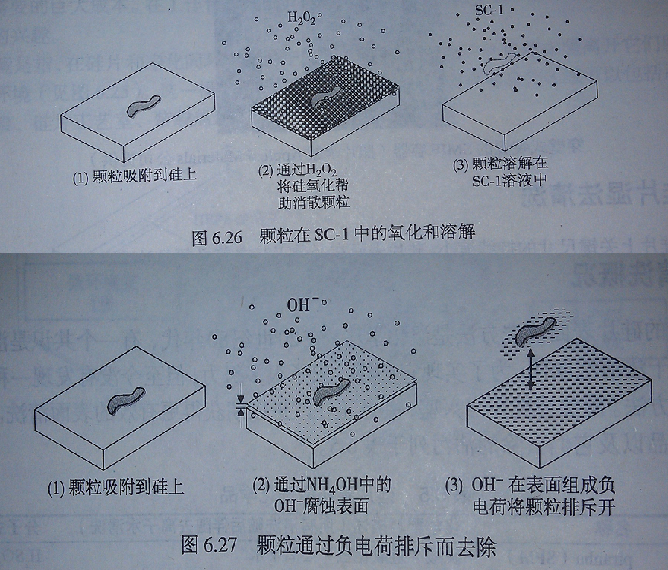
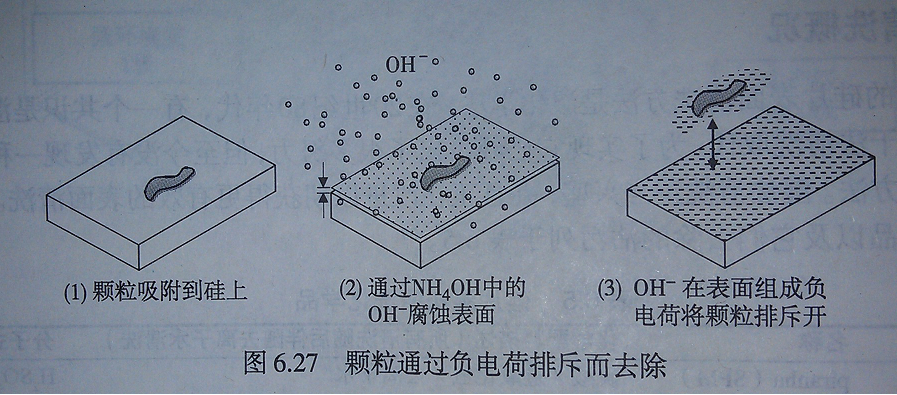
RGA清洗


清洗步骤 | 目的 |
H2SO4/H2O2(Piranha) | 有机物和金属 |
UPW清洗(超纯水) | 清洗 |
HF/ H2O | 自然氧化层 |
UPW清洗 | 清洗 |
NH4OH/ H2O2/H2O(SC-1) | 颗粒 |
UPW清洗 | 清洗 |
HF/ H2O | 自然氧化层 |
UPW清洗 | 清洗 |
HCL/ H2O2/H2O(SC-2) | 金属 |
UPW清洗 | 清洗 |
HF/ H2O | 自然氧化层 |
UPW清洗 | 清洗 |
干燥 | 干燥 |
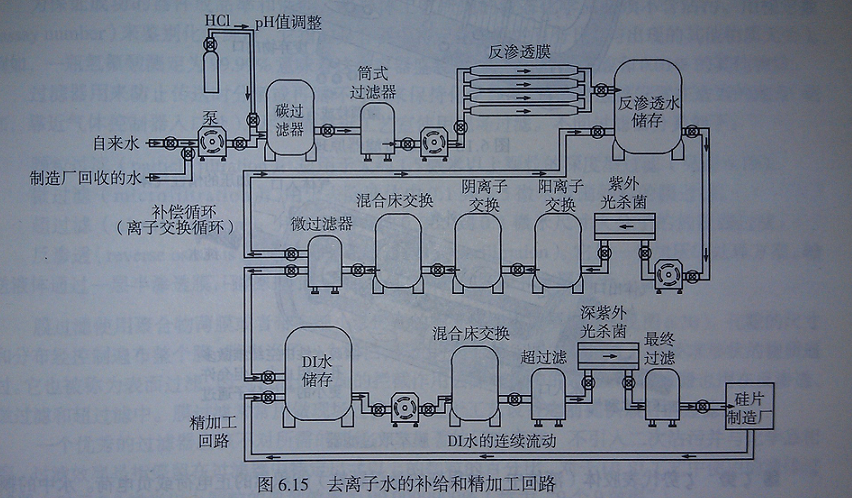
湿法清洗设备

兆声
兆声 结合SC-1用的最为广泛的一个湿法清洗技术是兆声清洗。兆声清洗在清洗的工艺中采用接近1M的兆声能量。这种工艺在更低的溶液温度下实现了更有效的颗粒去除即,使液温下降到40℃也能得到与80℃超声清洗去除颗粒的效果,而且又可避免超声清洗对晶片产生损伤。
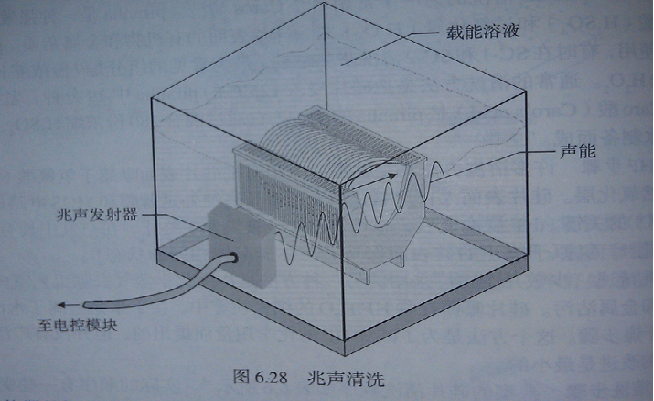
喷雾清洗
在喷雾的清洗的技术中,湿法清洗化学品被喷射到置于旋转密封内片架的硅片上。每个清洗的步骤后,去离子水清洗溶液被喷射到硅片上,并且对去离子水的电阻率进行监控,以确定何时所有的化学物都被去除。喷射腔在工艺过程中被密封以隔离化学物和他们的蒸汽。完成清洗和清洗循环之后,腔体充入加热的氮气洗涤,并加速旋转以甩干硅片。
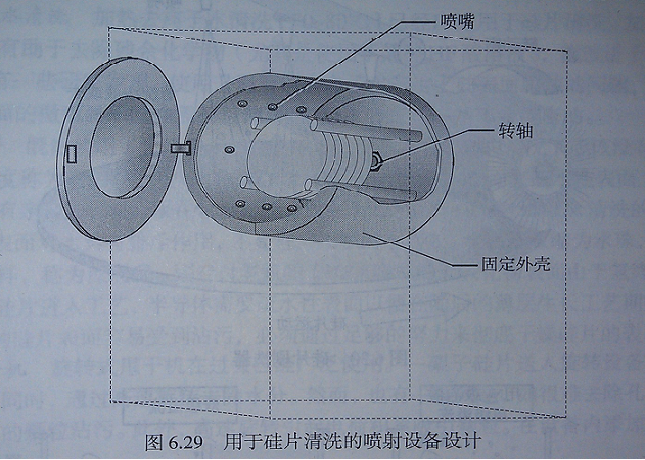
刷洗器
硅片刷洗是去除硅片表面颗粒的一种有效的方法。刷洗在化学机械抛光(CMP)后广泛运用,因为化学机械抛光产生大量的颗粒。刷洗能去除直径2微米或更小的颗粒。

水清洗

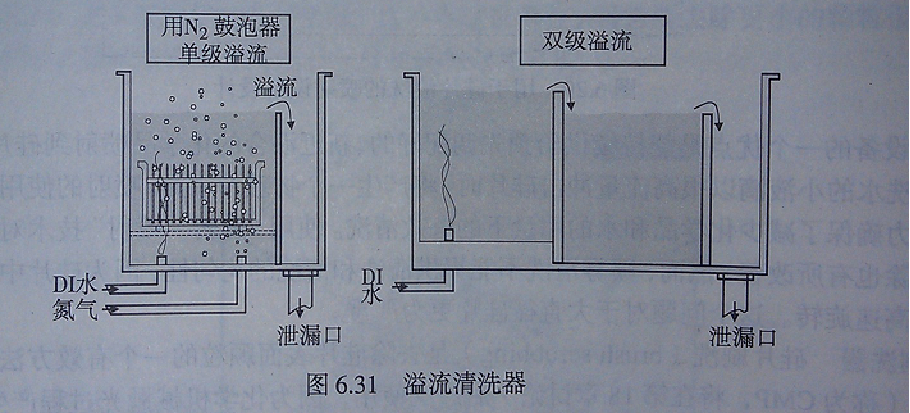

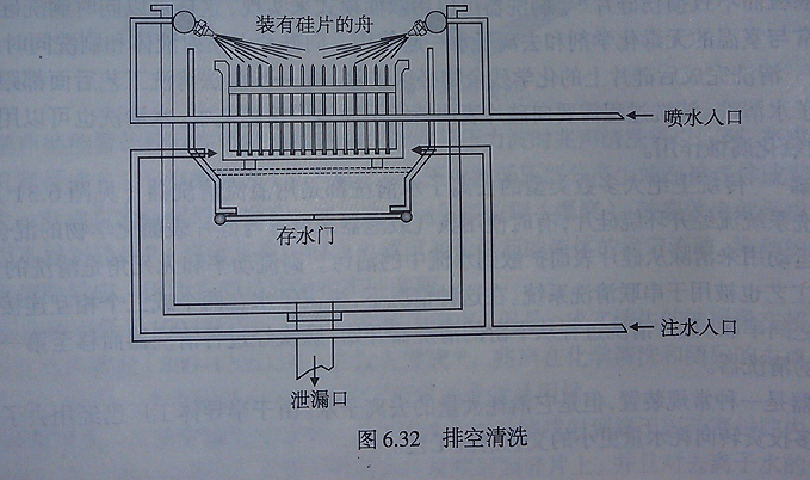
硅片甩干

干法清洗






