下一代光刻机发展趋势.
下一代光刻机(Next-Generation Lithography,简称NGL)领域的竞争激烈,是半导体制造业中至关重要的一部分。这些高度精密的设备在半导体工艺中用于将电路图案刻写到硅晶圆上,因此对于微电子产业的发展至关重要。本文将预测下一代光刻机的竞争局势以及一些最新的技术趋势和挑战。(四川成都有哪些半导体微组装设...

下一代光刻机(Next-Generation Lithography,简称NGL)领域的竞争激烈,是半导体制造业中至关重要的一部分。这些高度精密的设备在半导体工艺中用于将电路图案刻写到硅晶圆上,因此对于微电子产业的发展至关重要。本文将预测下一代光刻机的竞争局势以及一些最新的技术趋势和挑战。(四川成都有哪些半导体微组装设...
功率半导体器件有哪些? 功率半导体是电子装置中电能转换与电路控制的核心,主要用于改变电子装置中电压和频率、直流交流转换等。按照分类来看,功率半导体可以分为功率IC和功率分立器件两大类,其中功率分立器件主要包括二极管、晶闸管、晶体管等产品。(四川半导体微组装设备公司) 近年来,功率半导体的应用领域已从工业控制和消费电...

一、离子研磨技术简介离子研磨CP的原理是离子通过电场加速作用与样品表面从而产生溅射效应,使样品获得高质量的平滑表面。离子研磨属于无应力研磨,不会对样品表面造成机械损害,被广泛应用于电子材料、半导体、光伏材料、锂离子电池、页岩、矿石、陶瓷、金属材料、高分子材料、生物材料等等领域。(四川半导体微组装设备公司)氩气属于惰性气...

你即使从来没有学过物理,从来没学过数学也能看懂,但是有点太简单了,适合入门,如果你想了解更多的CMOS内容,就要看这一期的内容了,因为只有了解完工艺流程(也就是二极管的制作流程)之后,才可以继续了解后面的内容。那我们这一期就了解一下这个CMOS在foundry公司是怎么生产的(以非先进制程作为例子,先进制程的CMOS无...
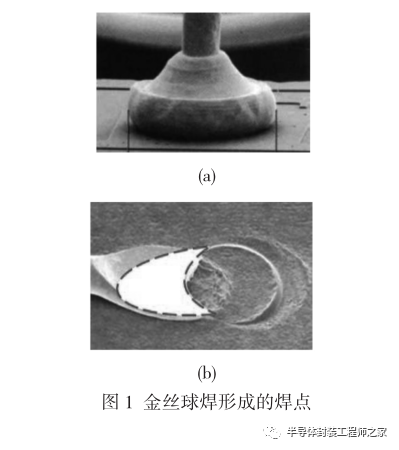
摘要:金丝键合是微组装制造工艺的关键工序,为解决电子产品金丝球焊合格率低的问题,根据金丝球焊的键合原理和工作过程,选取了键合压力、超声功率、超声时间、加热台温度等关键因素进行分析,得出金丝球焊是多种因素作用实现的,确定了设备的最优参数,并提出了改善金丝球焊工艺的方法。(四川半导体微组装设备公司)0 引言在微组装工艺中,...

芯片键合,作为切割工艺的后道工序,是将芯片固定到基板(substrate)上的一道工艺。引线键合(wire bonding)则作为芯片键合的下道工序,是确保电信号传输的一个过程。wire bonding是最常见一种键合方式。(四川半导体微组装设备厂家)Gold Bonding Wire: 半导体键合金线/金丝用于半导体...
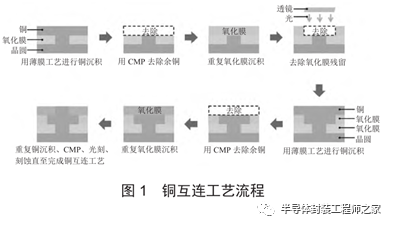
摘要:电化学沉积技术,作为集成电路制造的关键工艺技术之一,它是实现电气互连的基石,主要应用于集成电路制造的大马士革铜互连电镀工艺和后道先进封装 Bump、RDL、TSV 等电镀工艺。受 WLP、2.5D、3D、SIP 等先进封装技术的推动,未来 3 年市场空间可达 15~20 亿美元。0 引言(四川半导体微组装设备公司...

摘要:本文主要研究了808nm 高功率半导体激光器采用In焊料和AuSn焊料封装器件,对器件光电参数以及工作寿命的影响。结果显示In焊料封装器件功率高于AuSn焊料封装器件,In焊料封装器件波长比AuSn焊料封装器件短。而在工作寿命方面,AuSn焊料封装器件占有明显优势,经过500小时老化,结果显示In焊料封装器件功率...
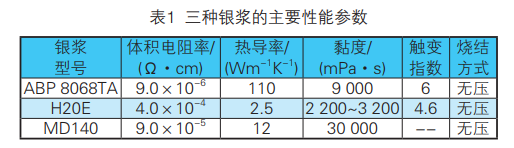
摘要:选取了一种半烧结型银浆进行粘接工艺研究,通过剪切强度测试和空洞率检测确定了合适的点胶工艺参数,并进行了红外热阻测试和可靠性测试。结果表明,该半烧结型银浆的工艺操作性好,烧结后胶层空洞率低;当胶层厚度控制在30μm左右时,剪切强度达到25.73MPa;采用半烧结型银浆+TSV转接板的方式烧结功放芯片,其导热性能满足...
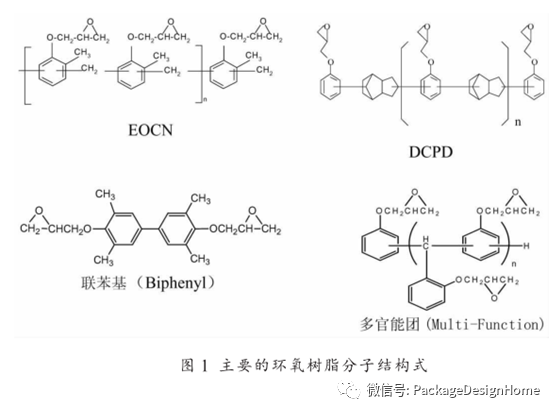
摘要: 环氧模塑料是一种重要的微电子封装材料, 是决定最终封装性能的主要材料之一, 具有低成本和高生产效率等优点, 目前已经成为半导体封装不可或缺的重要材料。本文简单介绍了环氧模塑料在半导体封装中的重要作用和地位; 分析了环氧模塑料性能对半导体封装的影响, 并对不同半导体封装对环氧模塑料的不同要求进行了分析; 最后展望...
028-86723768
企业微信
