功率MOSFET
功率MOSFET是便携式设备中大功率开关电源的主要组成部分。此外,对于散热量极低的笔记本电脑来说,这些MOSFET是最难确定的元件。本文给出了计算MOSFET功耗以及确定其工作温度的步骤,并通过多相、同步整流、降压型CPU核电源中一个30A单相的分布计算示例,详细说明了上述概念。(四川半导体微组装设备公司)也许,今天的...

功率MOSFET是便携式设备中大功率开关电源的主要组成部分。此外,对于散热量极低的笔记本电脑来说,这些MOSFET是最难确定的元件。本文给出了计算MOSFET功耗以及确定其工作温度的步骤,并通过多相、同步整流、降压型CPU核电源中一个30A单相的分布计算示例,详细说明了上述概念。(四川半导体微组装设备公司)也许,今天的...
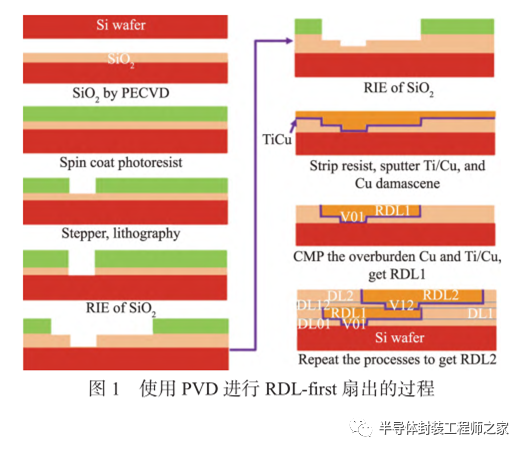
摘要:随着摩尔定律逐步达到极限,大量行业巨头暂停了 7 nm 以下工艺的研发,转而将目光投向先进封装领域。其中再布线先行( RDL-first ) 工艺作为先进封装技术的重要组成部分,因其具备高良率、高密度布线的优势吸引了大量研究者的目光。总结了 RDL-first 工艺的技术路线及优势,详细介绍其工艺进展,模拟其在程...
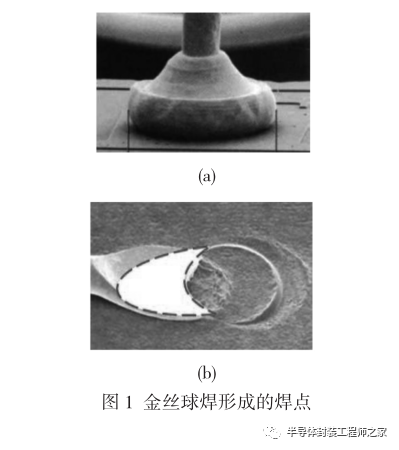
摘要:金丝键合是微组装制造工艺的关键工序,为解决电子产品金丝球焊合格率低的问题,根据金丝球焊的键合原理和工作过程,选取了键合压力、超声功率、超声时间、加热台温度等关键因素进行分析,得出金丝球焊是多种因素作用实现的,确定了设备的最优参数,并提出了改善金丝球焊工艺的方法。(四川半导体微组装设备公司)0 引言在微组装工艺中,...

芯片键合,作为切割工艺的后道工序,是将芯片固定到基板(substrate)上的一道工艺。引线键合(wire bonding)则作为芯片键合的下道工序,是确保电信号传输的一个过程。wire bonding是最常见一种键合方式。(四川半导体微组装设备厂家)Gold Bonding Wire: 半导体键合金线/金丝用于半导体...
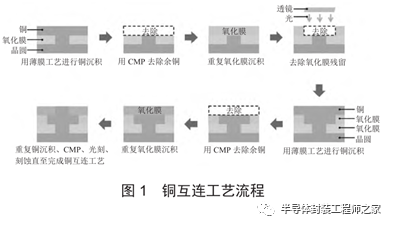
摘要:电化学沉积技术,作为集成电路制造的关键工艺技术之一,它是实现电气互连的基石,主要应用于集成电路制造的大马士革铜互连电镀工艺和后道先进封装 Bump、RDL、TSV 等电镀工艺。受 WLP、2.5D、3D、SIP 等先进封装技术的推动,未来 3 年市场空间可达 15~20 亿美元。0 引言(四川半导体微组装设备公司...
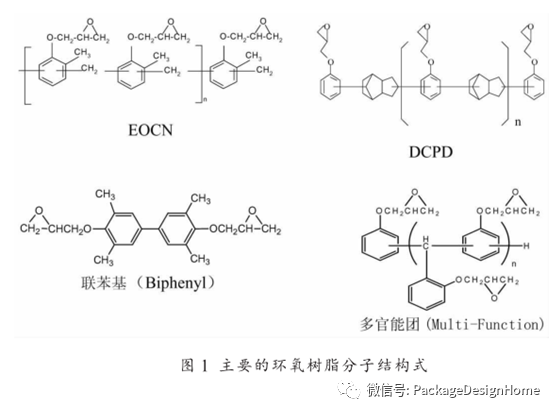
摘要: 环氧模塑料是一种重要的微电子封装材料, 是决定最终封装性能的主要材料之一, 具有低成本和高生产效率等优点, 目前已经成为半导体封装不可或缺的重要材料。本文简单介绍了环氧模塑料在半导体封装中的重要作用和地位; 分析了环氧模塑料性能对半导体封装的影响, 并对不同半导体封装对环氧模塑料的不同要求进行了分析; 最后展望...

摩尔定律——多种解释(四川半导体微组装设备公司)摩尔定律是戈登摩尔的观察结果,即计算机芯片中的晶体管数量每两年增加一倍。这条定律经常被许多人误解。晶体管密度——工艺节点中每平方毫米的芯片面积可以封装多少个晶体管——只是该方程的一小部分。即使每个新工艺节点的晶体管密度加倍,如果在新工艺节点中获得特定性能的成本和功耗高于...

金丝键合技术是微电子领域的封装技术,一般采用金线,利用热、压、超声共同作用,完成微电子器件中电路内部连接,即芯片和电路或者引线框架之间的互连。本文在深入了解键合机理后,选用25μm金丝,基于正交试验方法,研究键合压力、超声功率、键合时间等参数对楔焊键合及球焊键合后金丝拉力及焊点形貌的影响,根据键合强度拉力值确定键合的最...
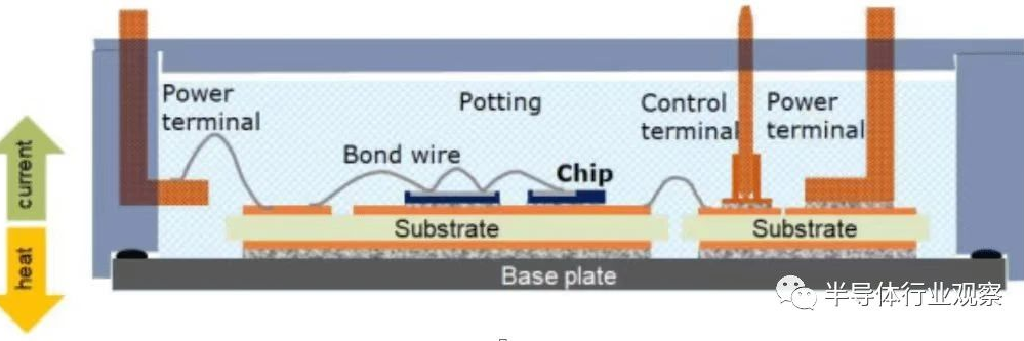
在电动汽车和可再生能源的采用的推动下,功率半导体市场有望在未来几年实现显著增长,同时也推动保护和连接这些设备所需的封装发生巨大变化。(四川成都有哪些半导体微组装设备公司?)封装在向更高功率密度的过渡中发挥着越来越重要的作用,从而实现更高效的电源、电力传输、更快的转换以及更高的可靠性。随着全球转向更快的开关频率和更高的功...
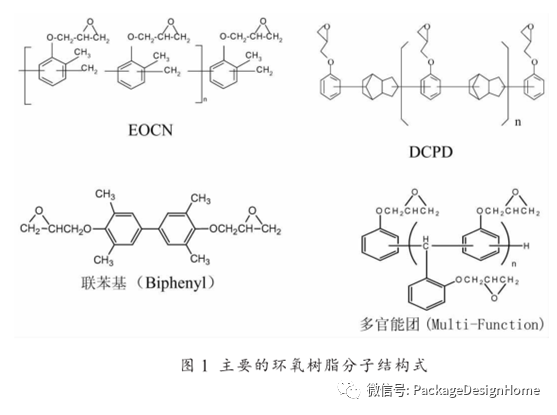
摘要: 环氧模塑料是一种重要的微电子封装材料, 是决定最终封装性能的主要材料之一, 具有低成本和高生产效率等优点, 目前已经成为半导体封装不可或缺的重要材料。本文简单介绍了环氧模塑料在半导体封装中的重要作用和地位; 分析了环氧模塑料性能对半导体封装的影响, 并对不同半导体封装对环氧模塑料的不同要求进行了分析; 最后展望...
028-86723768
企业微信
