3D封装,全产业链缺一不可
3D封装成大势所趋,技术挑战不容小觑随着芯片微缩愈加困难,而市场对芯片高性能的追逐不减,业界开始探索在封装领域寻求突破,所以这几年,诸如2.5D/3D的先进IC

3D封装成大势所趋,技术挑战不容小觑随着芯片微缩愈加困难,而市场对芯片高性能的追逐不减,业界开始探索在封装领域寻求突破,所以这几年,诸如2.5D/3D的先进IC
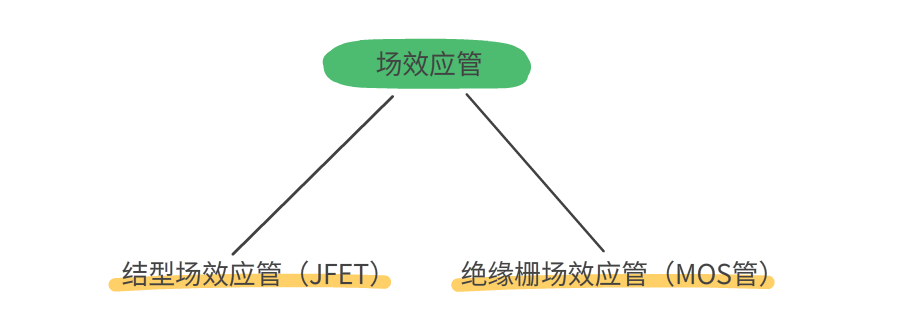
在电路设计中,MOS管和IGBT管会经常出现,它们都可以作为开关元件来使用,MOS管和IGBT管在外形及特性参数也比较相似,那为什么有些电路用MOS管?而有些电

作为电子工程师,相信大家都对MOSFET不会陌生。工程师们要选用某个型号的 MOSFET,首先要看的就是规格书-datasheet,拿到 MOSFET 的规格-

摘要:随着人工智能 ( AI )和集成电路的飞速发展,人工智能芯片逐渐成为全球科技竞争的焦点。在后摩尔时代,AI 芯片的算力提升和功耗降低越来越依靠具有硅通孔、

摘要:塑封器件具有体积小、成本低的优点,逐步替代气密性封装器件,广泛地应用于我国军用产品中。军用塑封SIP(System In Package)产品集成度高、结

摘要:通过采用单因素试验方法,研究了金丝球焊键合过程中超声功率、超声时间、超声压力和加热台温度对于键合强度的影响,分析了各个参数对金丝键合强度的影响规律,给出了
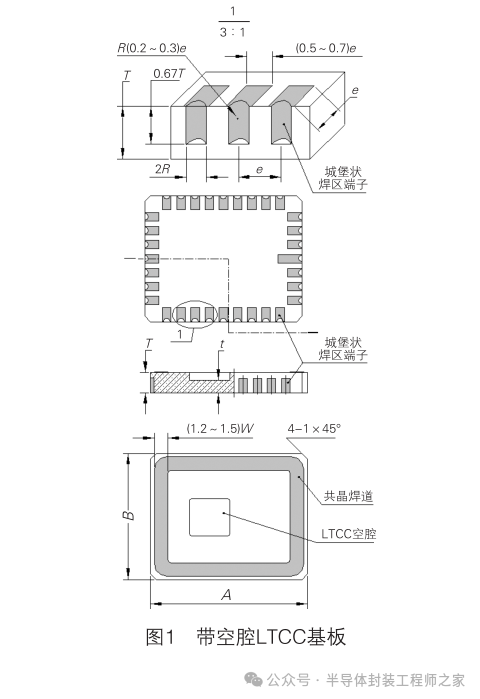
摘要:通过封装结构设计及其制造工艺流程和LTCC基板加工、围框与基板共晶焊接、平行缝焊封盖等制造工艺的研究,成功研制了适于多芯片、多元器件微电子模块的LTCC一
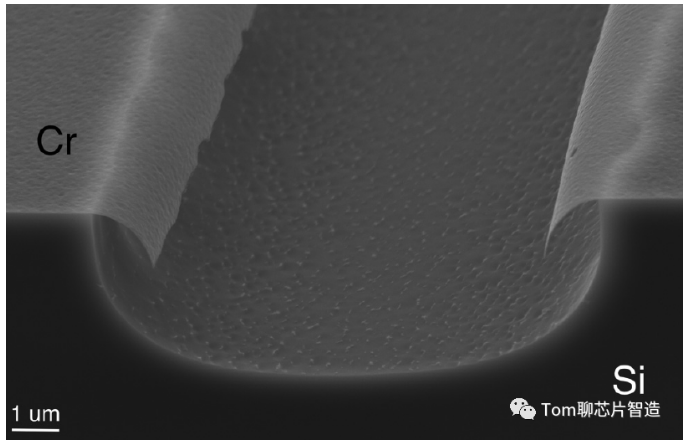
湿法刻蚀,对于12寸的逻辑,存储等线宽极小的晶圆厂来说,几乎已经销声匿迹了,但是在功率器件,光电器件,mems传感器领域依旧应用广泛。 为什么湿法刻蚀

摘要:对微电子模块气密性封焊技术的研究现状进行了总结,综述了平行缝焊技术、钎焊封焊技术及激光封焊技术的工艺特点及应用领域,重点介绍了不同气密性封焊技术对结构设计

碳化硅(SiC),碳化硅晶片的主要应用领域有LED固体照明和高频率高功率器件。该材料具有高出传统硅数倍的禁带、漂移速度、击穿电压、热导率、耐高温等优良特性,在高
028-86723768
企业微信
