封装—打线键合工艺
芯片由晶圆切割成单独的颗粒后,再经过芯片封装过程即可单独应用。 1、减薄(Back Grind)(四川半导体设备公司):芯片依工艺要求,需有一定之厚度。应用研磨的方法,达到减薄的目标。研磨的第一步为粗磨,第二步为细磨,目的为消减芯片粗磨中生成的应力破坏层(一般厚度为1~2μm左右)。2、贴膜(Wafer Moun...

芯片由晶圆切割成单独的颗粒后,再经过芯片封装过程即可单独应用。 1、减薄(Back Grind)(四川半导体设备公司):芯片依工艺要求,需有一定之厚度。应用研磨的方法,达到减薄的目标。研磨的第一步为粗磨,第二步为细磨,目的为消减芯片粗磨中生成的应力破坏层(一般厚度为1~2μm左右)。2、贴膜(Wafer Moun...

随着先进封装的不断推进,SiP技术、3D封装等技术逐渐显露出巨大潜力,封测设备在半导体设备行业中的占比逐渐提升。中国大陆先进封装市场正成为提升产业链能力的一大方向,加上新兴市场的需求增长,国产封装设备面临巨大缺口。在贴片机市场,高速度、高精度、高效率和高稳定性的贴片机研发成为封装设备国产化的拦路虎。随着SiP系统级封装...

随着科技的不断进步,半导体设备正在变得越来越小型化。微组装技术的出现为半导体行业带来了新的发展机遇。然而,微小的尺寸也带来了新的挑战,其中最大的挑战之一就是如何有效地清洗微小的半导体器件。(四川半导体设备:气相清洗机)为了解决这一问题,气相清洗机应运而生。气相清洗机是一种利用气体流动原理进行清洗的设备,其主要作用是将微...

颗粒和金属杂质沾污会严重影响器件的性能、可靠性和成品率伴随半导体的诞生,清洗就融入了制程多样组合清洗方式,极大提升了硅晶圆表面清洁度随着半导体技术的不断发展,对工艺技术的要求越来越高...
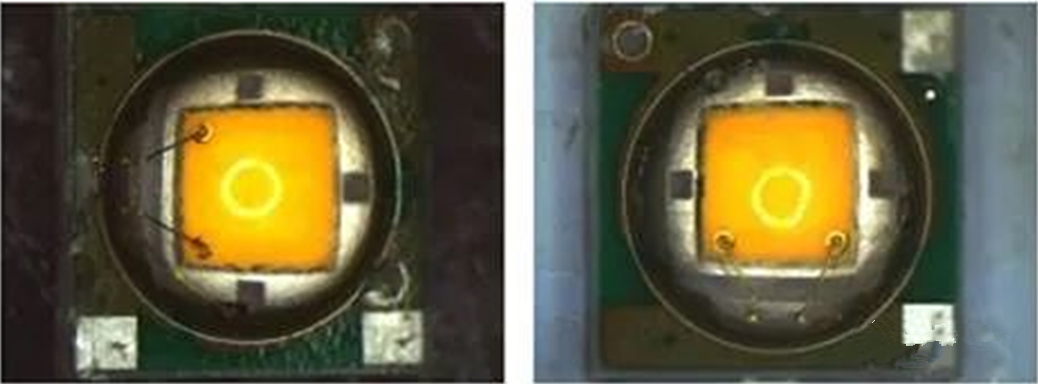
LED是一种直接将电能转换为可见光和辐射能的发光器件,具有耗电量小、发光效率高、体积小等优点,目前已经逐渐成为了一种新型高效节能产品,并且被广泛应用于显示、照明、背光等诸多领域。近年来,随着LED技术的不断进步,其发光效率也有了显著的提升,现有的蓝光LED系统效率可以达到60%,而白光LED的光效已经超过150lm/W...

碳化硅产业链图谱碳化硅产业链主要由衬底、外延、器件、应用等环节组成。碳化硅晶片作为半导体衬底材料,根据电阻率不同可分为导电型、半绝缘型。导电型衬底可用于生长碳化硅外延片,制成耐高温、耐高压的碳化硅二极管、碳化硅MOSFET等功率器件,应用于新能源汽车、光伏发电、轨道交通、智能电网、航空航天等领域;半绝缘型衬底可用于生长...

目前集成电路的封装内部最常见的方式有「打线封装(Wire bonding)」与「覆晶封装(FCP:Flip Chip Package)」两种,如果芯片的正面朝上,也就是含有黏着垫的那一面朝上,通常使用「打线封装(Wafer bonding)1.Wire bond原理:对金属丝和压焊点同时加热和超声波,接触面便产生塑性变...

1.功率芯片是什么?(四川半导体微组装设备)近年来,我国已成为全球发电量第一的大国。电能一直是人类消耗的最大能源,是目前最为重要的一种能源形式之一。为满足发电,输电和用电的各种不同要求需求,几乎所有的电能从生产到消耗的过程中都要经过电压、电流、频率等参数的转换以后才能供设备使用。而电能的转换本质是利用功率芯片的开关作用...
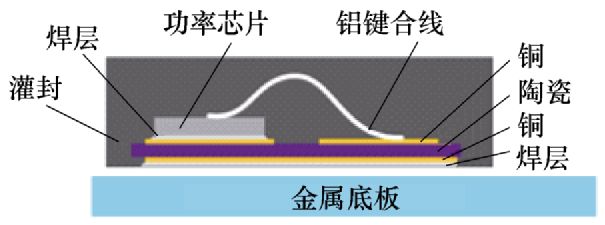
功率芯片通过封装实现与外部电路的连接,其性能的发挥则依赖着封装的支持,在大功率场合下通常功率芯片会被封装为功率模块进行使用。芯片互连(interconnection)指芯片上表面的电气连接,在传统模块中一般为铝键合线。(四川半导体封装设备)图 传统功率模块封装截面目前商用碳化硅功率模块仍然多沿用这种引线键合的传统硅 I...

全球半导体制造商预计将在 2026 年将 300 毫米晶圆厂的产能提高到每月 960 万片晶圆的历史新高。(四川半导体设备制造商)近日,SEMI在其300 毫米晶圆厂展望中宣布,全球半导体制造商预计将在 2026 年将 300 毫米晶圆厂的产能提高到每月 960 万片晶圆 (wpm) 的历史新高。在经历了 2021 年...
028-86723768
企业微信
